O wire bonding com fio de ouro (gold wire bonding) é um método de interconexão maduro e altamente confiável, usado em encapsulamento de semicondutores e na montagem de dies diretamente em PCBs. Porém, quando o desempenho do bonding fica inconsistente, a causa raiz muitas vezes não está na máquina — e sim na superfície da PCB.
Se o seu projeto envolve Wire Bonding Gold Wire, dois fatores vão impactar diretamente o rendimento (bonding yield) e a confiabilidade no longo prazo:
- Espessura do ouro nas bond pads (mínimo 2 µin / 2U)
- Estrutura do acabamento de superfície (ENEPIG vs. ENIG)
Este guia explica por que 2U de ouro virou padrão, como a exposição do níquel pode gerar falhas “ocultas” e por que o ENEPIG costuma ser uma escolha mais segura.
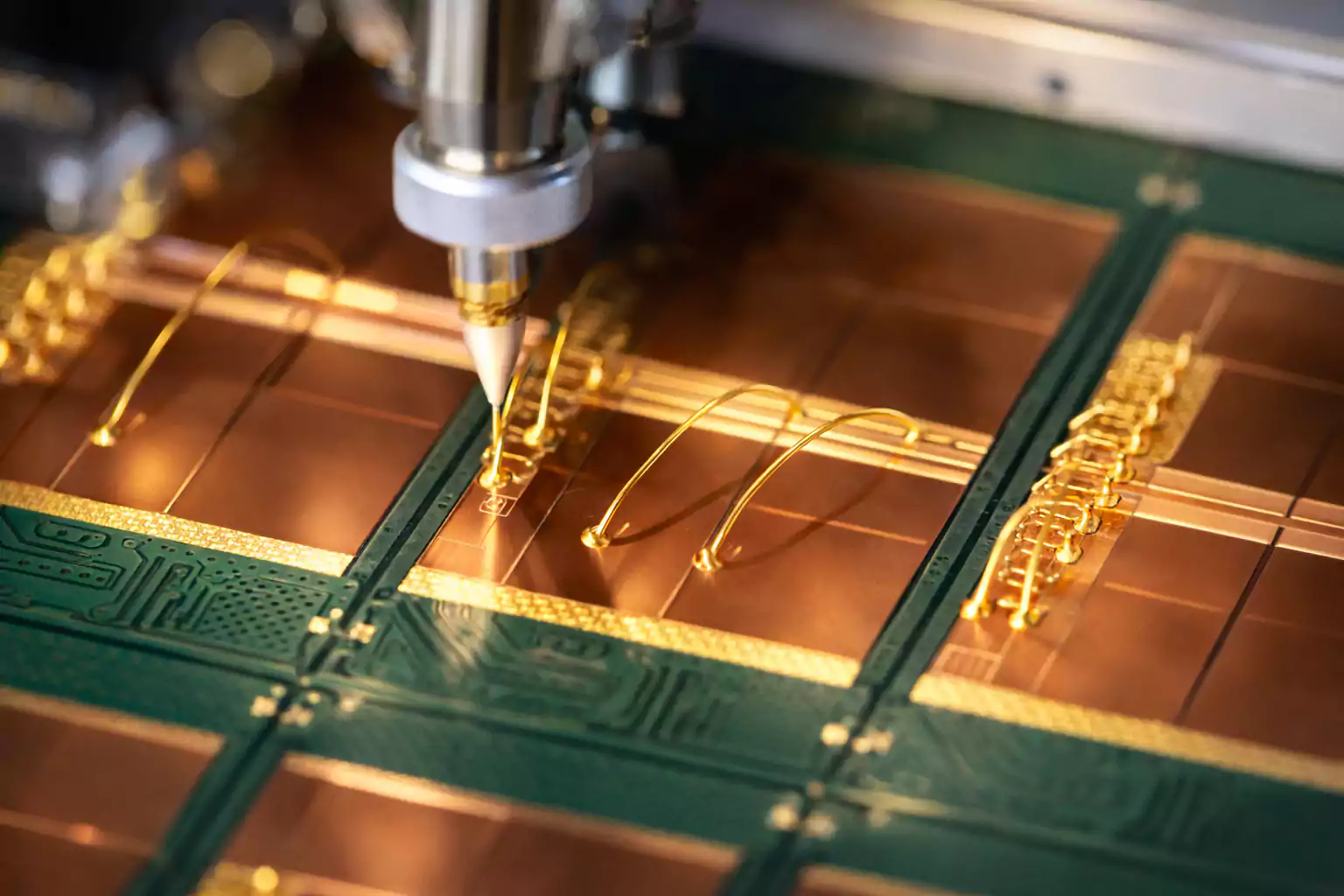
O que é Wire Bonding com fio de ouro?
Em aplicações de PCB, o wire bonding com fio de ouro é muito comum em:
- Montagens COB (Chip-on-Board)
- Módulos de sensores
- Módulos de LED
- Dispositivos RF e circuitos mixed-signal
- Circuitos híbridos personalizados
Diferente da soldagem, que usa metal fundido, o Wire Bonding Gold Wire é um processo em estado sólido (solid-state) que utiliza calor, pressão e energia ultrassônica controlados para formar uma ligação metalúrgica entre o fio de ouro e uma bond pad metalizada na PCB.
Como a ligação depende de contato metal-metal e difusão atômica, a condição da superfície e a estrutura do revestimento são mais importantes do que muitos engenheiros imaginam.
Ball Bonding vs. Wedge Bonding
A maioria das aplicações de wire bonding com fio de ouro em PCBs usa ball bonding (também chamado de ball-stitch bonding):
- Forma-se uma pequena esfera de ouro na ponta do fio.
- A esfera é pressionada contra uma pad aquecida.
- Aplica-se energia ultrassônica.
- Forma-se o primeiro bond.
- O fio faz o loop até a segunda pad.
- Um stitch bond é criado e o fio é finalizado.
Esse processo envolve deformação localizada e um micro “scrubbing” (esfregaçamento) na interface. Essa ação mecânica é o motivo pelo qual espessura do ouro e integridade da superfície são críticos.
O wedge bonding é usado em algumas aplicações, muitas vezes com fio de alumínio, mas o ball bonding com ouro domina na maioria dos cenários de die-attach em PCBs.

Por que 2U de espessura de ouro é o mínimo prático
1) O que significa “2U”?
2U significa 2 microinches (2 µin) de espessura de ouro.
Isso equivale a aproximadamente 0,05 microns (µm).
Na fabricação de PCBs, a espessura do ouro normalmente é especificada em microinches. Quando falamos em 2U gold thickness for wire bonding, estamos nos referindo à camada de immersion gold nos acabamentos ENIG ou ENEPIG.
2) Wire bonding não é um contato “leve”
Durante o bonding termossônico:
- A ferramenta aplica força.
- A energia ultrassônica introduz micro-scrubbing.
- Ocorre deformação plástica localizada.
Isso é intencional: o processo quebra filmes de superfície e permite difusão em estado sólido entre os metais.
No entanto, se a camada de ouro for fina demais, ela pode ser danificada ou parcialmente desgastada durante o bonding.
Quando isso acontece, a camada de níquel abaixo passa a participar da interface — e é aí que começam os problemas de confiabilidade.
3) Exposição do níquel: o risco “oculto” de confiabilidade
A exposição do níquel ocorre quando a camada de ouro é fina demais ou porosa, permitindo que a energia do bonding atravesse o ouro.
Quando o níquel passa a fazer parte da interface:
- Resultados de pull test ficam inconsistentes.
- Valores de shear apresentam maior variação.
- O bonding yield cai.
- A confiabilidade no longo prazo piora sob ciclos térmicos ou umidade.
O níquel não se comporta como o ouro na interface. Ele altera a janela de processo (process window) e aumenta a sensibilidade a pequenas mudanças de parâmetros.
Correção importante: no texto original aparece “> 2 µm”. Aqui, o correto é > 2 µin (microinches), e não microns.
Por isso, 2U (2 µin) é considerado uma margem prática de segurança. Ele oferece:
- Tolerância ao desgaste durante o ultrassom
- Uma interface ouro-ouro mais estável
- Menor risco de variabilidade no bonding
4) Quando você pode precisar de mais do que 2U
Embora 2U seja suficiente em muitos casos, algumas aplicações justificam metas maiores:
- Bonding com pitch ultrafino
- Configurações de ultrassom mais altas
- Cenários de retrabalho/rebond
- Produtos automotivos ou industriais de alta confiabilidade
- Dispositivos de longa vida sob estresse térmico
Nesses casos, especificar um valor mínimo e um alvo (minimum + target) pode estabilizar ainda mais o bonding yield.
Acabamento de superfície para wire bonding: ENEPIG vs. ENIG
A espessura do ouro sozinha não basta. A estrutura abaixo do ouro tem um papel importante no desempenho do bonding.
Os dois acabamentos mais comuns para bond pads são:
- ENIG (Electroless Nickel Immersion Gold)
- ENEPIG (Electroless Nickel Electroless Palladium Immersion Gold)
1) ENIG e o risco de Black Pad
Estrutura do ENIG:
Cobre → Níquel químico → Ouro por imersão (immersion gold)
No ENIG, o ouro por imersão deposita diretamente sobre o níquel por uma reação de deslocamento. Em certas condições químicas, esse processo pode atacar os contornos de grão do níquel.
O resultado pode ser uma camada frágil e rica em fósforo — conhecida como black pad.
Em soldagem, o black pad pode causar juntas frágeis. No wire bonding, ele pode contribuir para:
- Instabilidade na resistência do bond
- Inconsistência na interface
- Maior variação no bonding yield
Os processos modernos de ENIG são bem controlados, mas, estruturalmente, o ouro ainda é depositado diretamente sobre o níquel.
2) Por que o ENEPIG funciona melhor para wire bonding com fio de ouro
Estrutura do ENEPIG:
Cobre → Níquel químico → Paládio químico → Ouro por imersão
A diferença-chave é a camada de paládio.
O paládio atua como:
- Barreira de difusão
- Metal nobre resistente à corrosão
- Camada protetora sobre o níquel
No ENEPIG, o ouro por imersão deposita sobre o paládio, não diretamente sobre o níquel. Isso reduz a chance de corrosão do níquel e diminui bastante o risco de black pad.
Para aplicações de alta confiabilidade, o ENEPIG oferece uma interface mais estável e um bonding yield mais consistente do que o ENIG.

3) Quando o ENIG ainda é aceitável?
O ENIG pode ser suficiente quando:
- As exigências de confiabilidade são moderadas
- O pitch de bonding não é extremamente fino
- O fabricante mantém excelente controle de processo
- Há restrições fortes de custo
Por outro lado, quando a prioridade é:
- Máximo bonding yield
- Alta confiabilidade em wire bonding
- COB com pitch fino
- Eletrônica automotiva ou aplicações críticas
O ENEPIG costuma ser a opção mais segura e conservadora.
Outros fatores que afetam o bonding yield
Espessura de ouro e acabamento são fundamentais — mas não são as únicas variáveis.
1) Limpeza de superfície
Wire bonding com fio de ouro é extremamente sensível a contaminação:
- Resíduos orgânicos
- Impressões digitais
- Exposição a enxofre
- Formação de óxidos
- Contaminação por solder mask
Mesmo pequenas quantidades de contaminação podem estreitar a janela de processo e gerar rendimentos inconsistentes.
Manuseio limpo e embalagem adequada fazem diferença.
2) Geometria da pad e folga do solder mask
Uma pad mal definida pode prejudicar o bonding:
- “Encroachment” do solder mask
- Bordas irregulares
- Folga insuficiente
- Irregularidade de superfície
Em fine pitch, é essencial ter pads planas e geometria consistente para transferência uniforme da energia ultrassônica.
3) Armazenamento e manuseio
A condição de superfície pode degradar com o tempo se não for armazenada corretamente.
Boas práticas incluem:
- Embalagem controlada
- Armazenamento em ambiente anti-enxofre
- Minimizar exposição ao ar antes do bonding
- Evitar contato desnecessário com as bond pads
A estabilidade da superfície impacta diretamente a confiabilidade.
FAQ: Wire Bonding Gold Wire
Qual é a espessura 2U de ouro?
2U equivale a 2 microinches (2 µin), ou aproximadamente 0,05 microns. É um mínimo prático para wire bonding estável com fio de ouro.
Por que ENEPIG é preferido para gold wire bonding?
O ENEPIG inclui uma camada de paládio que protege o níquel e reduz o risco de black pad. Isso gera interfaces mais estáveis e rendimento mais consistente.
O que é black pad no ENIG?
Black pad é um defeito relacionado à corrosão na camada de níquel químico, que pode enfraquecer a interface e causar variação no desempenho mecânico.
Como evitar a exposição do níquel durante o bonding?
Especificar espessura adequada de ouro (≥ 2U mínimo).
Usar ENEPIG em aplicações de alta confiabilidade.
Garantir bom controle de processo na fabricação da PCB.
Evitar energia ultrassônica excessiva fora da janela de processo.
Considerações finais
Wire Bonding Gold Wire é confiável, mas sensível a variações na espessura do ouro e no acabamento de superfície, que afetam rendimento e confiabilidade no longo prazo.
Para a maioria das aplicações de wire bonding em PCBs:
- Espessura de ouro ≥ 2U deve ser considerada um requisito básico.
- ENEPIG é mais seguro do que ENIG em aplicações críticas de confiabilidade.
- Evitar exposição do níquel e minimizar risco de black pad são essenciais para desempenho estável.
Na FastTurnPCB, trabalhamos com clientes em montagens COB, módulos de fine pitch e eletrônicos de alta confiabilidade, garantindo que acabamento de superfície e espessura de ouro sejam especificados corretamente desde o início. Definir esses detalhes cedo ajuda a evitar perdas de yield caras mais adiante na produção.