El wire bonding con hilo de oro (gold wire bonding) es un método de interconexión maduro y altamente fiable, utilizado en el encapsulado de semiconductores y en el montaje de dies sobre PCBs. Sin embargo, cuando el rendimiento del bonding se vuelve inconsistente, la causa raíz muchas veces no está en la máquina — sino en la superficie de la PCB.
Si tu proyecto incluye Wire Bonding Gold Wire, dos factores impactarán directamente en el bonding yield (rendimiento/ratio de éxito) y en la fiabilidad a largo plazo:
- Espesor de oro en las bond pads (mínimo 2 µin / 2U)
- Estructura del acabado superficial (ENEPIG vs. ENIG)
Esta guía explica por qué el espesor de oro 2U es un estándar práctico, cómo la exposición del níquel puede provocar fallos “ocultos” y por qué ENEPIG suele ser una opción más segura.
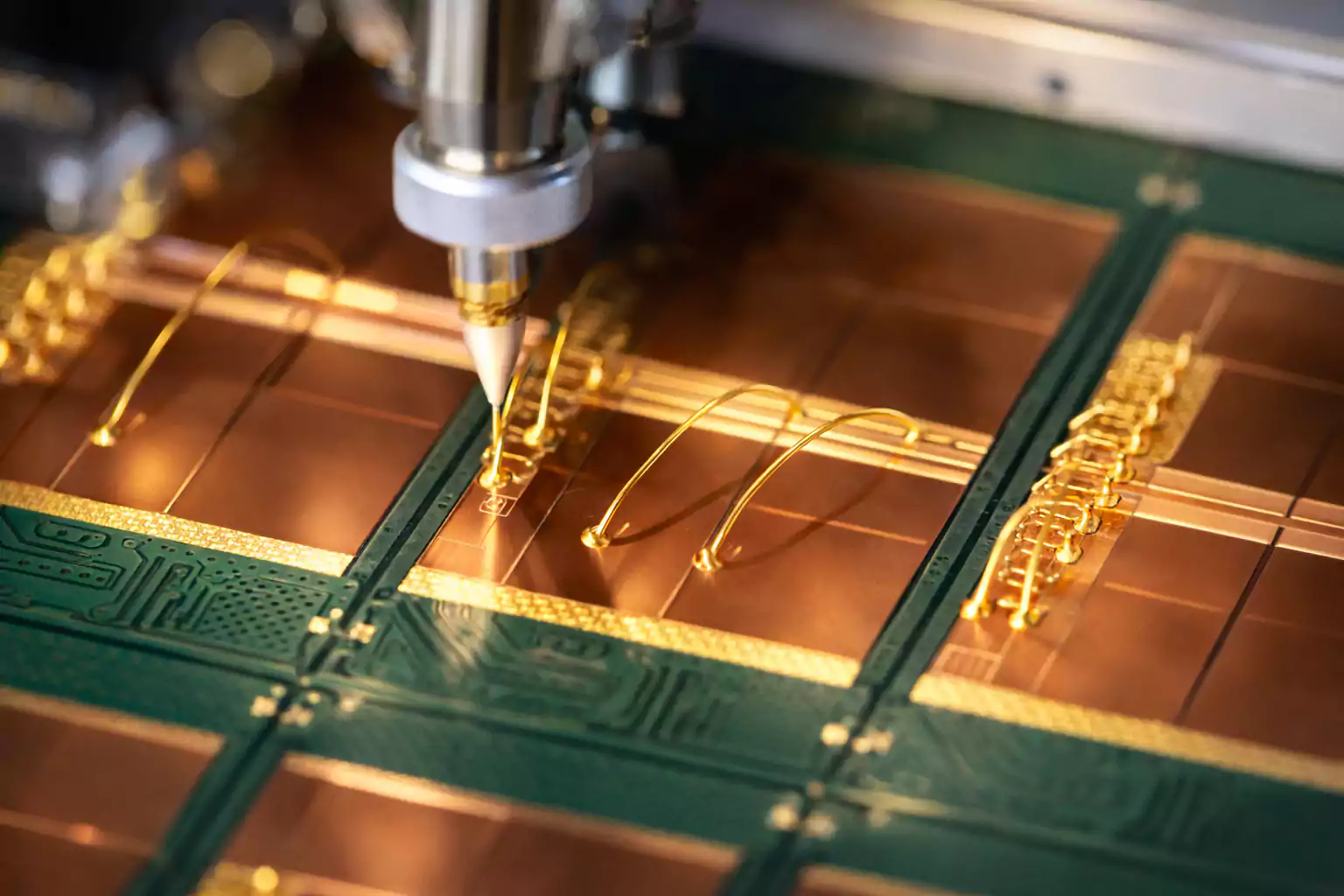
¿Qué es Wire Bonding con hilo de oro?
En aplicaciones de PCB, el wire bonding con hilo de oro se utiliza habitualmente en:
- Ensamblajes COB (Chip-on-Board)
- Módulos de sensores
- Módulos LED
- Dispositivos RF y circuitos mixed-signal
- Circuitos híbridos personalizados
A diferencia de la soldadura, que emplea metal fundido, el Wire Bonding Gold Wire es un proceso en estado sólido (solid-state). Utiliza calor, presión y energía ultrasónica controlados para formar una unión metalúrgica entre un hilo de oro y una bond pad metalizada en la PCB.
Como la unión depende del contacto metal-metal y de la difusión atómica, la condición de la superficie y la estructura del recubrimiento son más importantes de lo que muchos ingenieros imaginan.
Ball Bonding vs. Wedge Bonding
La mayoría de aplicaciones de wire bonding con hilo de oro en PCBs emplean ball bonding (también llamado ball-stitch bonding):
- Se forma una pequeña esfera de oro en la punta del hilo.
- La esfera se presiona sobre una pad calentada.
- Se aplica energía ultrasónica.
- Se forma el primer bond.
- El hilo hace el loop hacia la segunda pad.
- Se crea un stitch bond y se termina el hilo.
Este proceso implica deformación localizada y un micro “scrubbing” (frotamiento) en la interfaz. Precisamente por esa acción mecánica, el espesor del oro y la integridad de la superficie son críticos.
El wedge bonding se usa en algunas aplicaciones, a menudo con hilo de aluminio, pero el ball bonding con oro domina en la mayoría de entornos de die-attach sobre PCB.

Por qué 2U de espesor de oro es el mínimo práctico
1) ¿Qué significa “2U”?
2U significa 2 microinches (2 µin) de espesor de oro.
Eso equivale aproximadamente a 0,05 micras (µm).
El espesor del oro en fabricación de PCBs suele especificarse en microinches. Cuando hablamos de 2U gold thickness for wire bonding, nos referimos a la capa de immersion gold en acabados ENIG o ENEPIG.
2) El wire bonding no es un contacto “suave”
Durante el bonding termososónico:
- La herramienta aplica fuerza.
- La energía ultrasónica introduce micro-scrubbing.
- Se produce deformación plástica localizada.
Esto es intencionado: el proceso rompe películas superficiales y permite la difusión en estado sólido entre metales.
Sin embargo, si la capa de oro es demasiado fina, puede dañarse o desgastarse parcialmente durante el bonding.
Cuando eso ocurre, la capa de níquel subyacente entra en la interfaz — y ahí es donde empiezan los problemas de fiabilidad.
3) Exposición de níquel: el riesgo “oculto” de fiabilidad
La exposición de níquel ocurre cuando la capa de oro es demasiado fina o porosa, permitiendo que la energía del bonding la atraviese.
Cuando el níquel pasa a formar parte de la interfaz:
- Los resultados de pull test se vuelven inconsistentes.
- Los valores de shear muestran mayor variación.
- Baja el bonding yield.
- La fiabilidad a largo plazo se degrada con ciclos térmicos o humedad.
El níquel no se comporta como el oro en la interfaz. Cambia la ventana de proceso (process window) y aumenta la sensibilidad a pequeños cambios de parámetros.
Corrección importante: en el texto original aparece “> 2 µm”. En este contexto, el orden correcto es > 2 µin (microinches), no micras.
Por eso 2U (2 µin) se considera un margen práctico de seguridad. Aporta:
- Tolerancia al desgaste durante el ultrasonido
- Una interfaz oro-oro más estable
- Menor riesgo de variabilidad en el bonding
4) Cuándo puede hacer falta más que 2U
Aunque 2U suele ser suficiente, algunas aplicaciones justifican objetivos mayores:
- Bonding de paso ultra fino (ultra-fine pitch)
- Ajustes de energía ultrasónica más altos
- Escenarios de retrabajo o rebond
- Productos automoción o industriales de alta fiabilidad
- Dispositivos de larga vida bajo estrés térmico
En estos casos, especificar un mínimo y un objetivo (minimum + target) puede estabilizar todavía más el bonding yield.
Acabado superficial para wire bonding: ENEPIG vs. ENIG
El espesor de oro por sí solo no basta. La estructura bajo el oro influye mucho en el rendimiento del bonding.
Los dos acabados más comunes en bond pads son:
- ENIG (Electroless Nickel Immersion Gold)
- ENEPIG (Electroless Nickel Electroless Palladium Immersion Gold)
1) ENIG y el riesgo de Black Pad
Estructura ENIG:
Cobre → Níquel químico → Oro por inmersión
En ENIG, el oro por inmersión se deposita directamente sobre el níquel mediante una reacción de desplazamiento. Bajo ciertas condiciones químicas, este proceso puede atacar los límites de grano del níquel.
El resultado puede ser una capa frágil rica en fósforo — conocida como black pad.
En soldadura, el black pad puede provocar uniones frágiles. En wire bonding puede contribuir a:
- Inestabilidad en la resistencia del bond
- Inconsistencia en la interfaz
- Mayor variabilidad en el bonding yield
Aunque los procesos ENIG modernos están bien controlados, estructuralmente el oro se deposita directamente sobre el níquel.
2) Por qué ENEPIG funciona mejor para wire bonding con hilo de oro
Estructura ENEPIG:
Cobre → Níquel químico → Paladio químico → Oro por inmersión
La diferencia clave es la capa de paladio.
El paladio actúa como:
- Barrera de difusión
- Metal noble resistente a la corrosión
- Capa protectora sobre el níquel
En ENEPIG, el oro por inmersión se deposita sobre el paladio, no directamente sobre el níquel. Esto reduce la probabilidad de corrosión del níquel y disminuye notablemente el riesgo de black pad.
Para aplicaciones de alta fiabilidad, ENEPIG ofrece una interfaz más estable y un bonding yield más consistente que ENIG.

3) ¿Cuándo sigue siendo aceptable ENIG?
ENIG puede ser suficiente cuando:
- Los requisitos de fiabilidad son moderados
- El paso de bonding no es extremadamente fino
- El fabricante mantiene un excelente control de proceso
- Las restricciones de coste son importantes
Sin embargo, cuando la prioridad es:
- Máximo bonding yield
- Alta fiabilidad en wire bonding
- COB de paso fino
- Electrónica de automoción o aplicaciones críticas
ENEPIG suele ser la opción más segura y conservadora.
Otros factores que afectan el bonding yield
El espesor de oro y el acabado de superficie son fundamentales — pero no son las únicas variables.
1) Limpieza de superficie
El wire bonding con hilo de oro es extremadamente sensible a la contaminación:
- Residuos orgánicos
- Huellas dactilares
- Exposición a azufre
- Formación de óxidos
- Contaminación de solder mask
Incluso pequeñas cantidades de contaminación pueden estrechar la ventana de proceso y generar rendimientos inconsistentes.
Un manejo limpio y un buen embalaje importan.
2) Geometría de la pad y holgura del solder mask
Una mala definición de la pad puede afectar negativamente:
- Invasión del solder mask (encroachment)
- Bordes irregulares
- Holgura insuficiente
- Irregularidad de superficie
En bonding de paso fino, se requiere planitud y geometría consistente para transferir energía ultrasónica de forma uniforme.
3) Almacenamiento y manipulación
La condición de la superficie puede degradarse con el tiempo si no se almacena adecuadamente.
Buenas prácticas:
- Embalaje controlado
- Entornos anti-azufre
- Minimizar la exposición al aire antes del bonding
- Evitar contacto innecesario con las bond pads
La estabilidad de la superficie afecta directamente la fiabilidad.
FAQ: Wire Bonding Gold Wire
¿Qué es el espesor de oro 2U?
2U equivale a 2 microinches (2 µin), o aproximadamente 0,05 micras. Es un mínimo práctico para un wire bonding estable con hilo de oro.
¿Por qué se prefiere ENEPIG para gold wire bonding?
ENEPIG incluye una capa de paladio que protege el níquel y reduce el riesgo de black pad. Esto da interfaces más estables y un rendimiento más consistente.
¿Qué es black pad en ENIG?
Black pad es un defecto relacionado con la corrosión en la capa de níquel químico que puede debilitar la interfaz y causar variabilidad en el rendimiento mecánico.
¿Cómo se evita la exposición de níquel durante el bonding?
Especificar un espesor de oro adecuado (≥ 2U mínimo).
Usar ENEPIG en aplicaciones de alta fiabilidad.
Asegurar un buen control de proceso en la fabricación de la PCB.
Evitar energía ultrasónica excesiva fuera de la ventana de proceso.
Conclusión
El Wire Bonding Gold Wire es fiable, pero sensible a variaciones en el espesor de oro y en el acabado superficial, que afectan el rendimiento y la fiabilidad a largo plazo.
Para la mayoría de aplicaciones de wire bonding en PCB:
- Espesor de oro ≥ 2U debe considerarse un requisito base.
- ENEPIG es más seguro que ENIG en aplicaciones críticas de fiabilidad.
- Evitar la exposición de níquel y minimizar el riesgo de black pad son claves para un rendimiento estable.
En FastTurnPCB, trabajamos con clientes en ensamblajes COB, módulos de paso fino y electrónica de alta fiabilidad, asegurando que el acabado de superficie y el espesor de oro se especifiquen correctamente desde el inicio. Definir bien estos detalles al principio puede evitar pérdidas de yield costosas más adelante en producción.