Los fallos por CAF rara vez aparecen durante la fase de prototipado. Las placas superan las pruebas eléctricas, las comprobaciones funcionales iniciales y, a menudo, funcionan perfectamente en el laboratorio. Sin embargo—tras meses o años en campo—empiezan a aparecer síntomas sutiles: reinicios inesperados, corrientes de fuga en redes que antes estaban “tranquilas”, pérdida intermitente de señal de alta velocidad o, en el peor de los casos, un cortocircuito catastrófico.
El responsable en muchas investigaciones de fiabilidad a largo plazo es el Conductive Anodic Filament (CAF): un filamento de cobre interno y oculto que crece lentamente a través del dieléctrico del PCB hasta formar un puente conductor entre dos conductores que nunca deberían haberse conectado.
Este artículo explica qué es el CAF, por qué se forma y—lo más importante—cómo diseñar PCBs que prevengan activamente el crecimiento del CAF.
¿Qué es exactamente el CAF y por qué provoca fallos en campo?
El Conductive Anodic Filament (CAF) es un modo de fallo electroquímico interno en placas de circuito impreso. En lugar de formarse en la superficie, el CAF crece dentro del laminado, normalmente a lo largo de la interfaz entre haces de fibra de vidrio y el sistema de resina. A medida que la humedad entra en la placa y existe un diferencial de tensión, los iones de cobre migran desde un ánodo hacia un cátodo, depositando metal hasta formar un camino conductor.
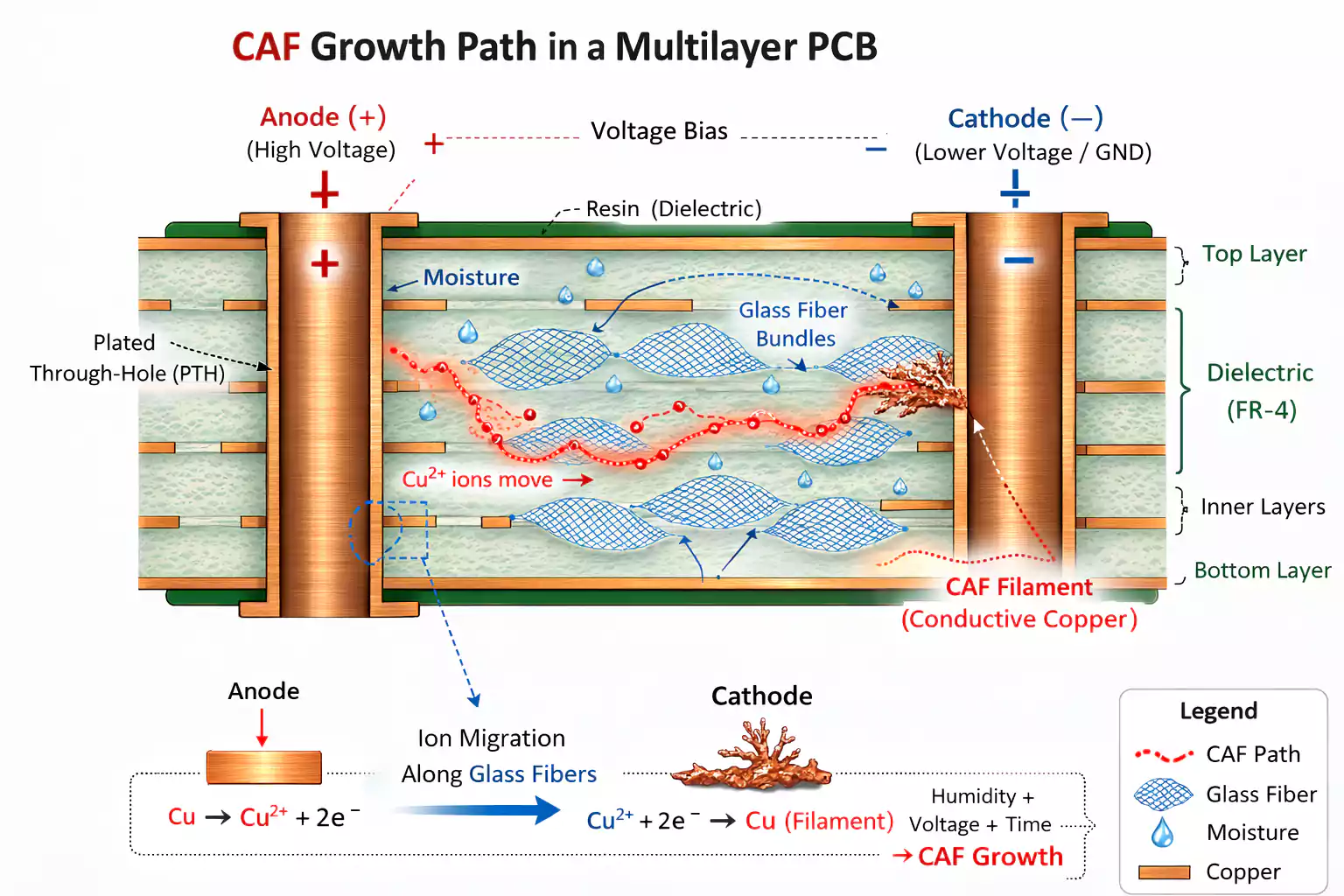
El CAF es peligroso porque:
- Es invisible: no se detecta mediante inspección visual.
- Progresa lentamente, por lo que la placa parece correcta al principio y falla más adelante.
- Produce problemas intermitentes difíciles de reproducir.
- Puede provocar fugas en el rango de microamperios, fallos lógicos o cortocircuitos completos.
En resumen, el CAF es un riesgo de fiabilidad latente: solo aparece cuando se combinan las condiciones de estrés adecuadas—humedad, tensión, tiempo y una estructura de material favorable (o desfavorable).
Por qué ocurre el CAF: tres condiciones necesarias para que crezca el filamento
El mecanismo detrás del CAF es fundamentalmente electroquímico, no puramente eléctrico. Deben existir simultáneamente tres condiciones:
Humedad dentro del PCB
La humedad absorbida por el dieléctrico (especialmente FR-4) reduce la resistencia de aislamiento y proporciona una vía iónica.
Un sesgo de tensión entre dos conductores
Una tensión DC más alta acelera la disolución y la migración de iones de cobre.
Una ruta de material susceptible
La interfaz resina–vidrio, los vacíos, las microgrietas y las zonas pobres en resina crean canales físicos por los que los iones de cobre pueden migrar.
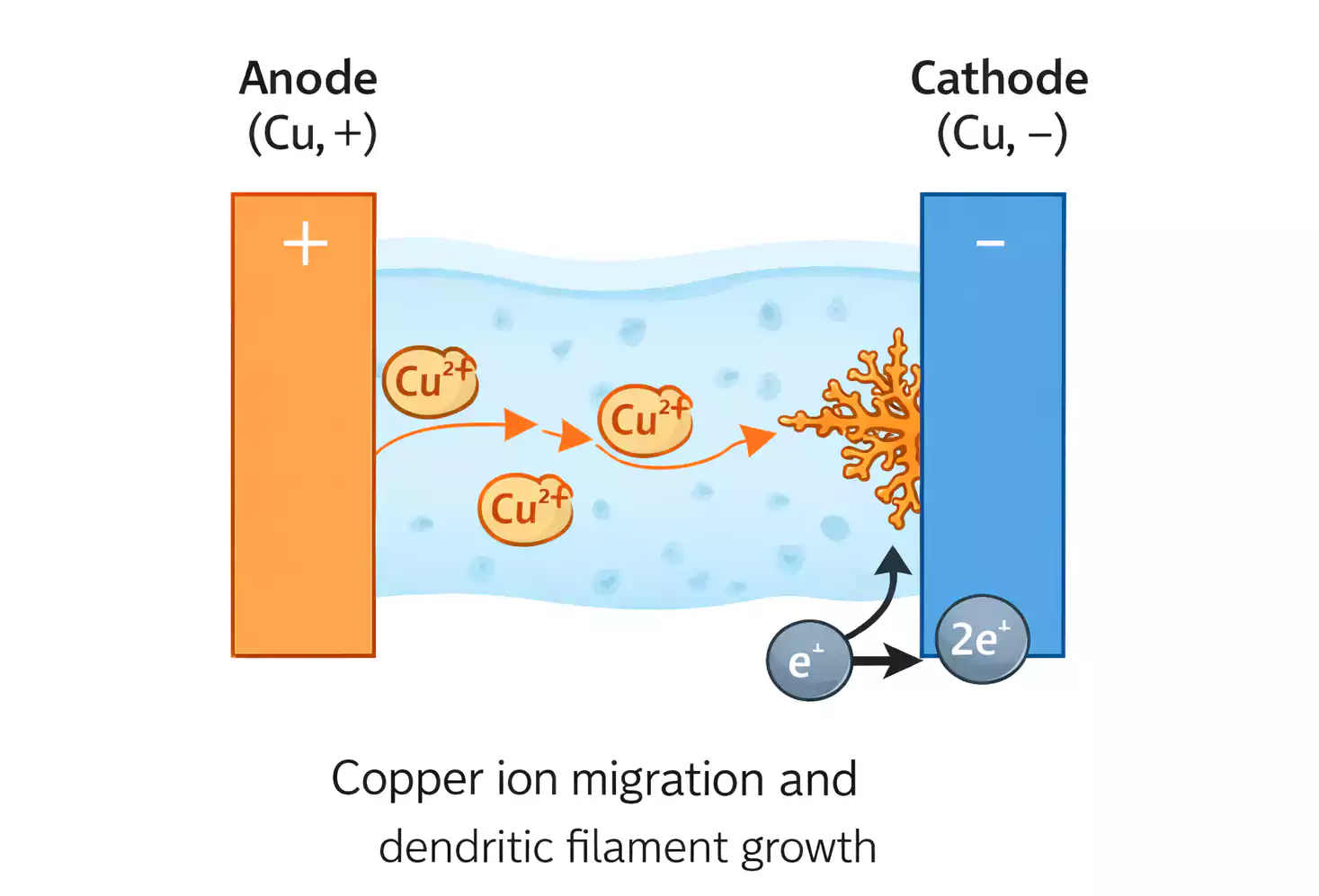
Secuencia electroquímica del crecimiento del CAF
- La humedad entra en la placa.
- El diferencial de tensión provoca la disolución del cobre en el ánodo.
- Los iones de cobre migran a lo largo de la interfaz vidrio/resina.
- Llegan al cátodo y se depositan formando un filamento metálico.
- Aumenta la fuga y, finalmente, aparece un cortocircuito “duro”.
El CAF prospera en entornos con alta humedad, sesgo DC sostenido y largos periodos de operación—exactamente el perfil de la electrónica de automoción, telecomunicaciones, industria, aeroespacial y medicina.
¿Cuándo debería un equipo de proyecto preocuparse por el CAF?
El CAF es especialmente crítico en proyectos que implican:
- Alta humedad o exposición a condensación
- Larga vida útil del producto (5–15 años o más)
- Diferencias de tensión DC sostenidas entre redes (nets)
- Campos de vías densos y apilados multicapa (stackups)
- Dieléctricos finos o construcción HDI
- Requisitos de fiabilidad (automoción, aeroespacial, telecomunicaciones o industrial)
Si tu diseño va a estar expuesto a humedad, tensión y tiempo, el CAF debe tratarse como una restricción de diseño, no como un tema secundario.
Reglas de layout para evitar el crecimiento del CAF
Guía práctica y orientada a ingeniería
La mayor parte de la mitigación del CAF no se consigue solo con materiales, fabricación o pruebas—se logra en la fase de diseño. Un buen layout reduce drásticamente la susceptibilidad al CAF antes de enviar el PCB a fabricación.
Estas son seis reglas de layout especialmente efectivas.
1) Aumenta el espaciado entre conductores con potenciales distintos
La diferencia de tensión es uno de los principales aceleradores del CAF. Aumentar la separación alarga la ruta de migración y reduce el campo eléctrico entre conductores.
Áreas clave donde aumentar el espaciado:
- Espaciado vía–vía, especialmente en capas internas
- Espaciado pista–vía
- Redes de polaridad opuesta en divisiones de plano o recortes
- Redes de alta tensión en zonas de enrutado denso
Las capas internas merecen un margen extra porque la humedad tiende a acumularse cerca del tejido de fibra de vidrio, donde los caminos de CAF se forman con mayor facilidad.
2) Elimina pads no conectados e islas de cobre en capas internas
Los pads “huérfanos” y formas de cobre no utilizadas en capas internas crean:
- Zonas pobres en resina
- Trampas de humedad
- Concentradores de tensión mecánica
Todo ello hace más probable el CAF.
Si un pad se necesita únicamente para soporte de taladrado, sigue las recomendaciones del fabricante para conservar solo el anillo mínimo de cobre, en lugar de dejar una gran isla de cobre sin uso.
3) Desplaza las vías ~45° para evitar caminos rectos de cobre a cobre
La alineación en línea recta de vías con polaridad opuesta crea una ruta geométrica directa para la migración iónica.
Correcciones sencillas:
- Girar pares de vías aproximadamente 45°
- O desplazar vías alternas 1–2 pasos (pitch)
Romper el camino recto reduce significativamente la probabilidad de CAF, porque los iones de cobre deben recorrer una ruta más larga y más tortuosa a través de la fibra de vidrio.

4) Planifica el espaciado de vías y evita filas paralelas largas de vías con polaridad opuesta
Al CAF le “gustan” las estructuras verticales largas, paralelas y muy próximas, como los barriles de las vías. Si esas vías llevan potenciales distintos, el riesgo se multiplica.
Buenas prácticas:
- Evita filas de vías paralelas a lo largo de grandes distancias
- Aumenta el drill-to-copper por encima del mínimo del fabricante
- Para PCBs de alta fiabilidad, añade 0,1–0,2 mm de holgura extra como regla de diseño
- Desplaza columnas de vías para interrumpir rutas continuas de CAF
Trata las reglas de drill-to-copper como requisitos de fiabilidad, no solo de fabricabilidad.
5) Evita “via farms” densas siempre que sea posible
Los grandes grupos de vías—especialmente bajo BGAs—pueden crear:
- Zonas de microgrietas
- Depleción local de resina
- Canales capilares para entrada de humedad
- Regiones con alto campo eléctrico
Si la densidad es inevitable:
- Haz el fan-out en varias etapas en lugar de un “bloque” muy apretado
- Inserta vacíos de cobre (keepouts) entre redes con potenciales distintos
- Evita agrupar vías analógicas, digitales y retornos de potencia
Pequeños cambios estructurales pueden reducir mucho el riesgo de CAF.
6) Usa “teardrops” en transiciones pad–pista y vía–pista
Los teardrops refuerzan la interfaz cobre–taladro y reducen el estrés mecánico durante el taladrado y el laminado. Esto minimiza:
- Microgrietas finas
- Microvacíos
- Zonas pobres en resina
Estos defectos microscópicos actúan como trampas de humedad y aceleran la formación del CAF.
Los teardrops son una mejora simple y de bajo coste—especialmente útil en enrutado de impedancia controlada y en breakouts de alta densidad.
Por qué la prevención del CAF también es un tema de fabricación y materiales
El CAF no es solo un fallo de diseño. Es un problema de sistema que depende de:
- Calidad del laminado (química de la resina, tejido de vidrio, adhesión)
- Limpieza en fabricación (contaminación iónica, control de humedad)
- Calidad del taladrado (smear en pared del agujero, grietas, retracción de resina)
- Disciplina en laminado y curado
- Uniformidad del metalizado del cobre
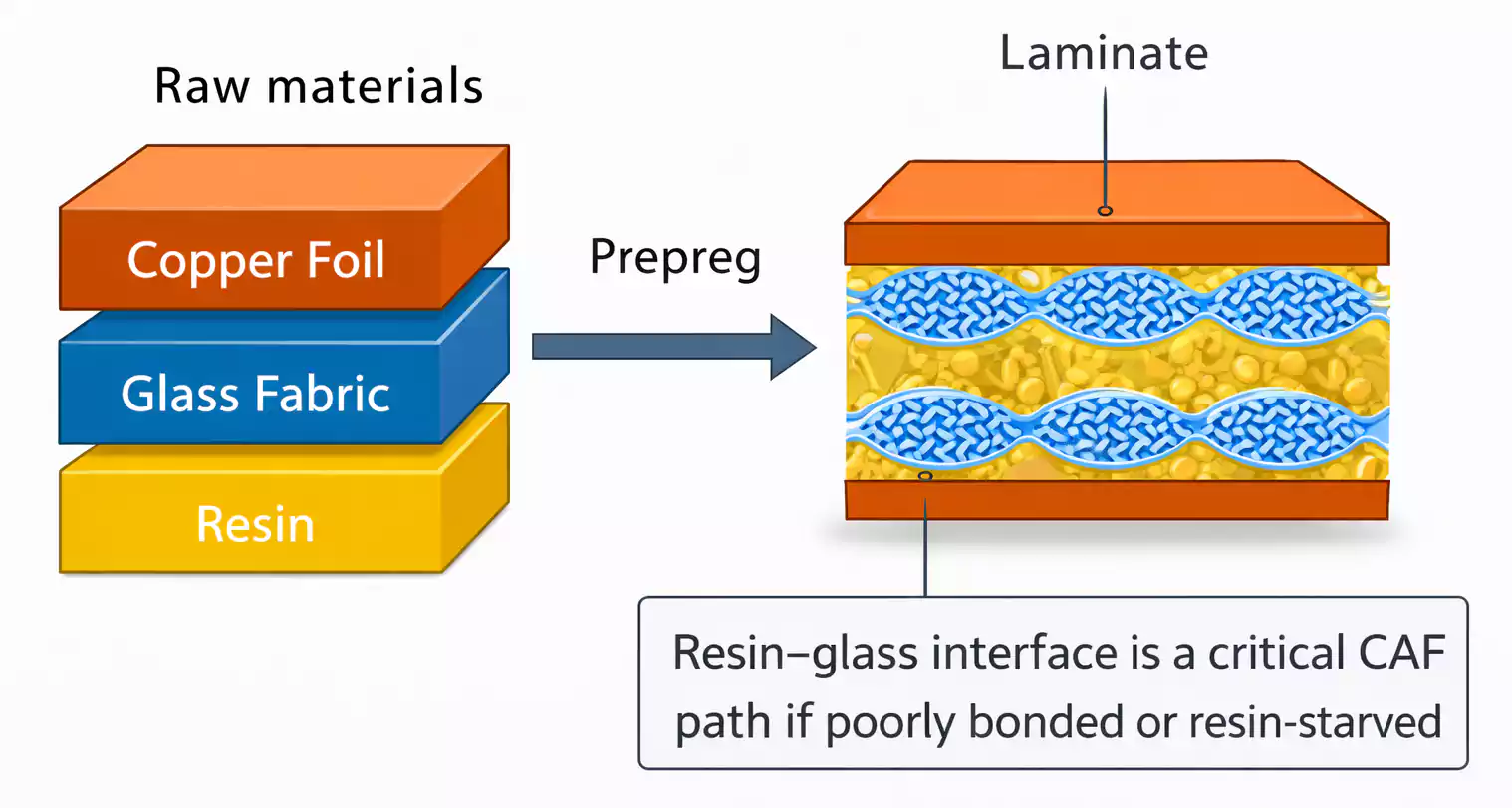
En diseños de alta fiabilidad, involucrar al fabricante pronto (DFM) ayuda a asegurar:
- Grados de laminado correctos (formulaciones resistentes a CAF)
- Selección adecuada de prepreg/resina
- Procesos controlados de desmear y taladrado
- Ciclos de horneado para eliminar humedad antes del laminado
- Stackup estable y elecciones consistentes de dieléctricos
Un buen diseño reduce drásticamente el riesgo; una fabricación disciplinada elimina las vulnerabilidades restantes.
FAQ CAF: preguntas más comunes entre ingenieros
¿Qué es el CAF y por qué es peligroso?
El CAF es un filamento conductor de cobre que crece dentro del PCB, conectando dos redes que deben permanecer aisladas. Puede causar fugas intermitentes, inestabilidad lógica o cortocircuitos catastróficos—normalmente tras meses o años en servicio.
¿Por qué aparece CAF en algunas placas y en otras no?
El CAF se forma cuando coinciden diseño muy denso, espaciados al límite, debilidades de material, humedad y sesgo de tensión. Incluso placas del mismo lote pueden comportarse distinto por variaciones microscópicas en la resina o el taladrado.
¿Cómo puede el layout reducir más el riesgo de CAF?
Las acciones más efectivas son: aumentar espaciados, evitar alineaciones rectas de vías, eliminar islas internas de cobre, dividir clusters densos de vías y usar teardrops.
¿Qué industrias deben tomarse el CAF muy en serio?
Telecomunicaciones, automoción, aeroespacial, control industrial y sistemas médicos—donde la fiabilidad a largo plazo bajo humedad o estrés de tensión es obligatoria.
¿Quién ayuda a garantizar stackups y procesos resistentes a CAF?
Un socio fiable de fabricación de PCBs puede orientar en selección de materiales, procesos de taladrado, sistemas de resina y control de humedad—todos críticos para mitigar el CAF.
Conclusión
El CAF es un problema sutil pero extremadamente importante para la fiabilidad de los PCBs multicapa modernos. Está impulsado por migración electroquímica, habilitado por la humedad y acelerado por la tensión y las debilidades del material. Afortunadamente, los ingenieros pueden prevenir el CAF desde el principio mediante decisiones de layout cuidadosas—como espaciado, desplazamiento de vías, limpieza de cobre y refuerzo estructural—combinadas con una buena selección de materiales y procesos de fabricación rigurosos.
Si estás diseñando hardware que debe sobrevivir años de humedad, estrés eléctrico y operación crítica, es clave abordar la prevención del CAF desde el primer día.