Das Gold-Drahtbonden (Gold Wire Bonding) ist eine ausgereifte und äußerst zuverlässige Verbindungstechnologie, die in der Halbleiterverpackung sowie bei der Die-Montage auf Leiterplatten (PCB) широко eingesetzt wird. Wenn die Bond-Qualität jedoch schwankt, liegt die Ursache oft nicht an der Bondmaschine – sondern an der Oberfläche der Leiterplatte.
Wenn Ihr Projekt Wire Bonding mit Golddraht umfasst, beeinflussen zwei Faktoren direkt Bonding Yield (Ausbeute) und Langzeitzuverlässigkeit:
- Goldschichtdicke auf den Bondpads (mindestens 2 µin / 2U)
- Oberflächenfinish-Struktur (ENEPIG vs. ENIG)
Dieser Leitfaden erklärt, warum 2U Gold als Standard gilt, wie Nickel-Exposition zu schwer erkennbaren Ausfällen führen kann und warum ENEPIG häufig die sicherere Wahl ist.
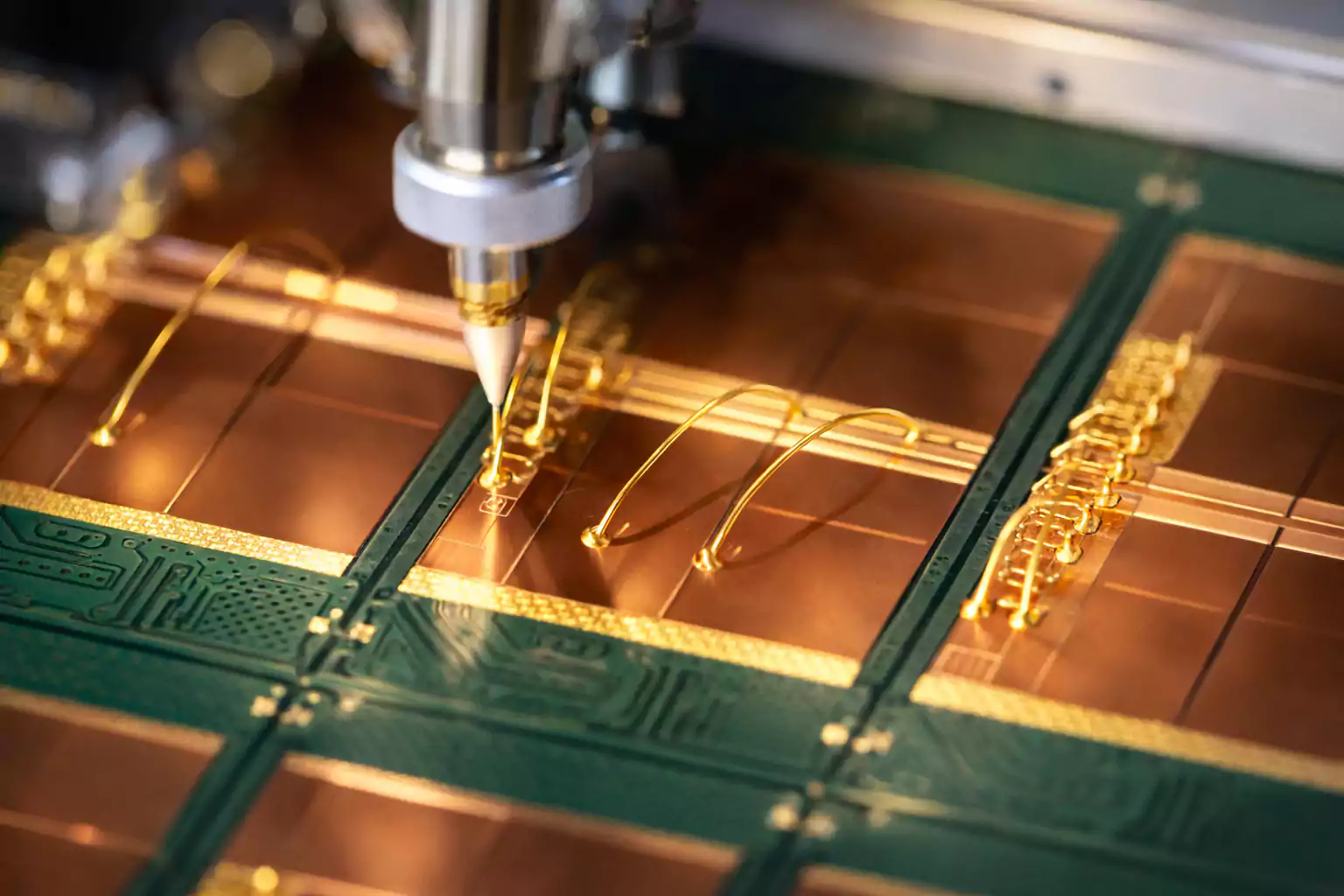
Was ist Wire Bonding mit Golddraht?
In PCB-Anwendungen wird Gold-Drahtbonden häufig eingesetzt für:
- COB (Chip-on-Board)-Baugruppen
- Sensormodule
- LED-Module
- RF- und Mixed-Signal-Bausteine
- kundenspezifische Hybrid-Schaltungen
Im Gegensatz zum Löten, das mit geschmolzenem Metall arbeitet, ist Wire Bonding mit Golddraht ein Festkörperprozess. Er nutzt kontrollierte Wärme, Druck und Ultraschallenergie, um eine metallurgische Verbindung zwischen Golddraht und metallisiertem PCB-Pad herzustellen.
Da der Bond auf Metall-zu-Metall-Kontakt und atomarer Diffusion basiert, sind Oberflächenzustand und Schichtaufbau entscheidender, als viele Ingenieur:innen erwarten.
Ball Bonding vs. Wedge Bonding
Die meisten PCB-Anwendungen mit Golddraht nutzen Ball Bonding (auch Ball-Stitch Bonding genannt):
- Am Drahtende wird eine kleine Goldkugel erzeugt.
- Die Kugel wird auf ein erhitztes Pad gedrückt.
- Ultraschallenergie wird aufgebracht.
- Der erste Bond entsteht.
- Der Draht wird als Loop zum zweiten Pad geführt.
- Ein Stitch-Bond wird gesetzt und der Draht wird getrennt.
Dieser Prozess beinhaltet lokale Verformung und mikroskopisches „Scrubbing“. Genau diese mechanische Wirkung macht Goldschichtdicke und Oberflächenintegrität so wichtig.
Wedge Bonding wird in bestimmten Anwendungen eingesetzt, häufig mit Aluminiumdraht, doch im PCB-basierten Die-Attach-Umfeld dominiert meist das Gold-Ball-Bonding.

Warum 2U Goldschichtdicke das praktische Minimum ist
1) Was bedeutet „2U“?
2U bedeutet 2 Mikro-Zoll (2 µin) Goldschichtdicke.
Das entspricht ungefähr 0,05 µm.
Die Goldschichtdicke wird in der PCB-Fertigung typischerweise in Mikro-Zoll angegeben. Wenn wir von 2U gold thickness for wire bonding sprechen, ist damit die Immersionsgold-Schicht auf ENIG- oder ENEPIG-Finishes gemeint.
2) Wire Bonding ist kein „sanfter Kontakt“
Beim thermosonischen Bonden:
- Der Bondkopf übt Kraft aus.
- Ultraschallenergie erzeugt Micro-Scrubbing.
- Es kommt zu lokaler plastischer Verformung.
Das ist beabsichtigt: Oberflächenfilme werden aufgebrochen und Festkörperdiffusion zwischen den Metallen wird ermöglicht.
Ist die Goldschicht jedoch zu dünn, kann sie beim Bonden beschädigt oder teilweise abgetragen werden.
Dann wird die darunterliegende Nickelschicht Teil der Grenzfläche – und genau dort beginnen Zuverlässigkeitsprobleme.
3) Nickel-Exposition: Das „versteckte“ Zuverlässigkeitsrisiko
Nickel-Exposition tritt auf, wenn die Goldschicht zu dünn oder porös ist, sodass die Bondenergie bis zum Nickel durchdringt.
Wenn Nickel an der Bond-Grenzfläche beteiligt ist:
- Pull-Testergebnisse werden uneinheitlich.
- Shear-Werte streuen stärker.
- Die Bonding-Ausbeute sinkt.
- Langzeitzuverlässigkeit leidet bei Temperaturwechseln oder Feuchte.
Nickel verhält sich an der Grenzfläche nicht wie Gold. Es verändert das Prozessfenster und erhöht die Empfindlichkeit gegenüber kleinen Parameteränderungen.
Wichtige Korrektur: Im Ausgangstext steht einmal „> 2 µm“. Hier ist jedoch der korrekte Größenbereich > 2 µin (Mikro-Zoll), nicht 2 Mikrometer.
Deshalb gilt 2U (2 µin) als praktische Sicherheitsmarge. Sie bietet:
- Verschleißtoleranz durch Ultraschallbonden
- eine stabilere Gold-zu-Gold-Grenzfläche
- geringeres Risiko für Bonding-Variabilität
4) Wann benötigen Sie mehr als 2U?
2U ist oft ausreichend, aber manche Anwendungen rechtfertigen höhere Zielwerte:
- Ultra-feines Pitch-Bonden
- höhere Ultraschallenergie-Einstellungen
- Rework- oder Rebond-Szenarien
- Automotive- oder Industrieprodukte mit hoher Zuverlässigkeitsanforderung
- langlebige Produkte unter thermischem Stress
In solchen Fällen kann die Spezifikation eines Mindestwerts plus Zielwerts die Ausbeute zusätzlich stabilisieren.
Oberflächenfinish für Wire Bonding: ENEPIG vs. ENIG
Goldschichtdicke allein reicht nicht. Der Schichtaufbau unter dem Gold beeinflusst die Bondleistung wesentlich.
Die zwei häufigsten Finishes für Bondpads sind:
- ENIG (Electroless Nickel Immersion Gold)
- ENEPIG (Electroless Nickel Electroless Palladium Immersion Gold)
1) ENIG und das Black-Pad-Risiko
ENIG-Aufbau:
Kupfer → chemisch Nickel → Immersionsgold
Bei ENIG wird Immersionsgold durch eine Verdrängungsreaktion direkt auf Nickel abgeschieden. Unter bestimmten chemischen Bedingungen kann dieser Prozess die Korngrenzen der Nickelschicht angreifen.
Das Ergebnis kann eine spröde, phosphorreiche Schicht sein – häufig als Black Pad bezeichnet.
Beim Löten kann Black Pad zu spröden Lötstellen führen. Beim Wire Bonding kann es verursachen:
- instabile Bondfestigkeit
- inkonsistente Grenzflächen
- höhere Streuung der Bonding-Ausbeute
Moderne ENIG-Prozesse sind zwar gut kontrolliert, aber strukturell wird das Gold weiterhin direkt auf Nickel abgeschieden.
2) Warum ENEPIG für Gold-Drahtbonden besser ist
ENEPIG-Aufbau:
Kupfer → chemisch Nickel → chemisch Palladium → Immersionsgold
Der entscheidende Unterschied ist die Palladiumschicht.
Palladium wirkt als:
- Diffusionsbarriere
- korrosionsbeständiges Edelmetall
- Schutzschicht über Nickel
Bei ENEPIG wird Immersionsgold auf Palladium abgeschieden – nicht direkt auf Nickel. Dadurch sinkt die Wahrscheinlichkeit von Nickelkorrosion deutlich und das Black-Pad-Risiko wird stark reduziert.
Für Anwendungen mit hohen Zuverlässigkeitsanforderungen bietet ENEPIG eine stabilere Grenzfläche und konstantere Bonding-Ausbeute als ENIG.

3) Wann ist ENIG trotzdem akzeptabel?
ENIG kann ausreichen, wenn:
- die Zuverlässigkeitsanforderungen moderat sind
- das Bond-Pitch nicht extrem fein ist
- der Leiterplattenhersteller strikte Prozesskontrolle hat
- starke Kostenvorgaben bestehen
Wenn jedoch folgende Ziele im Vordergrund stehen:
- maximale Bonding-Ausbeute
- hohe Wire-Bonding-Zuverlässigkeit
- Fine-Pitch-COB
- Automotive oder sicherheitskritische Elektronik
…ist ENEPIG in der Regel die sicherere und konservativere Wahl.
Weitere Faktoren, die die Bonding-Ausbeute beeinflussen
Goldschichtdicke und Finish sind zentral – aber nicht die einzigen Variablen.
1) Oberflächenreinheit
Gold-Drahtbonden ist extrem empfindlich gegenüber Kontamination:
- organische Rückstände
- Fingerabdrücke
- Schwefelexposition
- Oxidbildung
- Lötstoppmasken-Kontamination
Schon geringe Verunreinigungen können das Prozessfenster verengen und zu schwankenden Ausbeuten führen.
Saubere Handhabung und geeignetes Packaging sind daher entscheidend.
2) Pad-Geometrie und Lötstoppmasken-Freistellung
Schlechte Pad-Definition kann das Bonden beeinträchtigen:
- Masken-Encroachment
- ungleichmäßige Padkanten
- zu geringe Freistellung
- Oberflächenunregelmäßigkeiten
Fine-Pitch-Bonden erfordert besonders konsistente Pad-Planarität und Geometrie, um Ultraschallenergie gleichmäßig einzukoppeln.
3) Lagerung und Handling
Die Oberflächenqualität kann sich mit der Zeit verschlechtern, wenn die Lagerung nicht stimmt.
Best Practices:
- kontrollierte Verpackung
- Anti-Schwefel-Lagerbedingungen
- Luftkontakt vor dem Bonden minimieren
- unnötigen Kontakt mit Bondpads vermeiden
Oberflächenstabilität wirkt sich direkt auf die Bondzuverlässigkeit aus.
FAQ: Wire Bonding mit Golddraht
Was ist 2U Goldschichtdicke?
2U entspricht 2 µin (Mikro-Zoll) bzw. ca. 0,05 µm. Das ist ein praktischer Mindestwert für stabiles Gold-Drahtbonden.
Warum wird ENEPIG für Gold Wire Bonding bevorzugt?
ENEPIG enthält eine Palladiumschicht, die Nickel schützt und das Black-Pad-Risiko reduziert. Dadurch werden Grenzflächen stabiler und die Ausbeute konstanter.
Was ist Black Pad bei ENIG?
Black Pad ist ein korrosionsbedingter Defekt in der chemischen Nickelschicht, der die Grenzfläche schwächen und zu schwankender mechanischer Performance führen kann.
Wie verhindert man Nickel-Exposition beim Bonden?
ausreichende Goldschichtdicke spezifizieren (≥ 2U)
für hohe Zuverlässigkeit ENEPIG wählen
auf gute Prozesskontrolle beim PCB-Hersteller achten
keine übermäßige Ultraschallenergie außerhalb des Prozessfensters einsetzen
Fazit
Wire Bonding mit Golddraht ist zuverlässig, aber sensibel gegenüber Variationen bei Goldschichtdicke und Oberflächenfinish — und genau diese Faktoren bestimmen Ausbeute und Langzeitzuverlässigkeit.
Für die meisten PCB-Wire-Bonding-Anwendungen gilt:
- Goldschichtdicke ≥ 2U als Basisanforderung betrachten.
- ENEPIG ist für Zuverlässigkeits-kritische Anwendungen die sicherere Wahl gegenüber ENIG.
- Nickel-Exposition vermeiden und Black-Pad-Risiken minimieren sind entscheidend für stabile Performance.
Bei FastTurnPCB unterstützen wir Kunden bei COB-Baugruppen, Fine-Pitch-Modulen und hochzuverlässiger Elektronik und stellen sicher, dass Oberflächenfinish und Goldschichtdicke von Beginn an korrekt spezifiziert sind. Wer diese Details früh richtig festlegt, kann später teure Yield-Verluste in der Produktion vermeiden.