Отказы, связанные с CAF, редко проявляются на стадии прототипирования. Платы проходят электрические тесты, ранние функциональные проверки и часто безупречно работают в лаборатории. А затем — спустя месяцы или годы эксплуатации — появляются тонкие симптомы: неожиданные перезагрузки, токи утечки на ранее «тихих» цепях, периодические потери высокоскоростного сигнала или, в худшем случае, катастрофическое короткое замыкание.
Во многих расследованиях отказов на длительном горизонте причиной оказывается Conductive Anodic Filament (CAF) — скрытая внутренняя медная «нить», которая медленно растёт внутри диэлектрика PCB, пока не сформирует проводящий мостик между двумя проводниками, которые никогда не должны были соединяться.
В этой статье объясняется, что такое CAF, почему он возникает и — самое главное — как проектировать печатные платы так, чтобы активно предотвращать рост CAF.
Что такое CAF и почему он приводит к отказам «в поле»?
Conductive Anodic Filament (CAF) — это внутренний электрохимический механизм отказа в печатных платах. В отличие от поверхностных явлений, CAF развивается внутри ламината, обычно вдоль границы между пучками стекловолокна и системой смолы. Когда внутрь платы попадает влага и присутствует разность потенциалов, ионы меди мигрируют от анода к катоду, постепенно осаждаются и в итоге образуют проводящий путь.
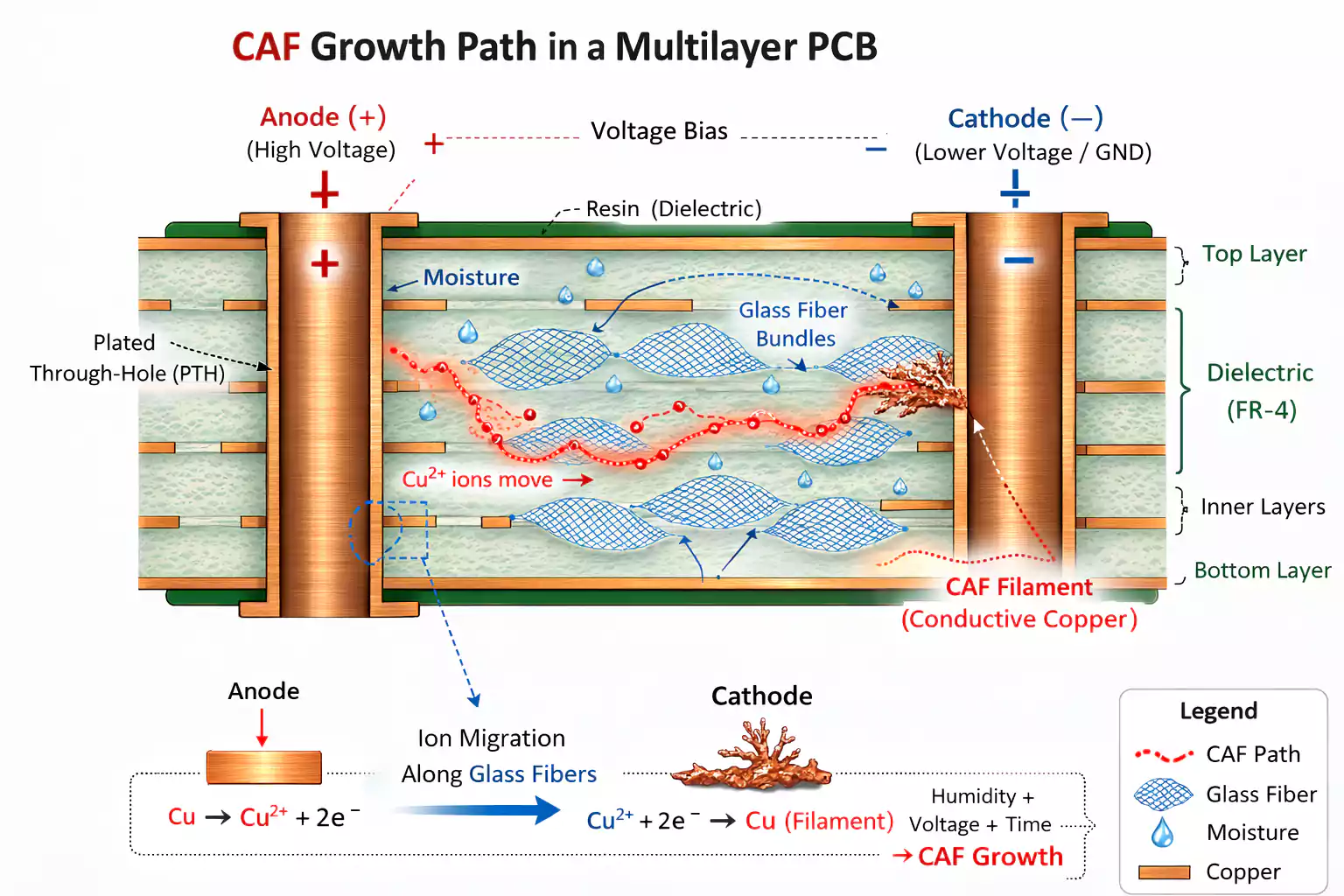
CAF опасен потому что:
- Он невидим — при визуальном контроле его не обнаружить.
- Он развивается медленно: плата кажется исправной вначале и выходит из строя позже.
- Он вызывает интермиттирующие (периодические) неисправности, которые сложно воспроизвести.
- Он может приводить к утечкам на уровне микроампер, сбоям логики или жёстким коротким замыканиям.
Проще говоря, CAF — это скрытый риск надёжности, который проявляется только при сочетании подходящих условий: влажность, напряжение, время и «правильная» (или, наоборот, неблагоприятная) структура материала.
Почему возникает CAF: три условия, необходимые для роста проводящей «нити»
Механизм CAF по своей природе электрохимический, а не чисто электрический. Три условия должны присутствовать одновременно:
Влага внутри PCB
Влага, поглощаемая диэлектриком (особенно FR-4), снижает сопротивление изоляции и создаёт ионный путь.
Смещение (bias) напряжения между двумя проводниками
Чем выше постоянное (DC) напряжение, тем быстрее происходит растворение меди и миграция её ионов.
Уязвимый материальный путь
Граница смола–стекловолокно, пустоты, микротрещины и зоны с недостатком смолы формируют физические каналы, по которым могут мигрировать ионы меди.
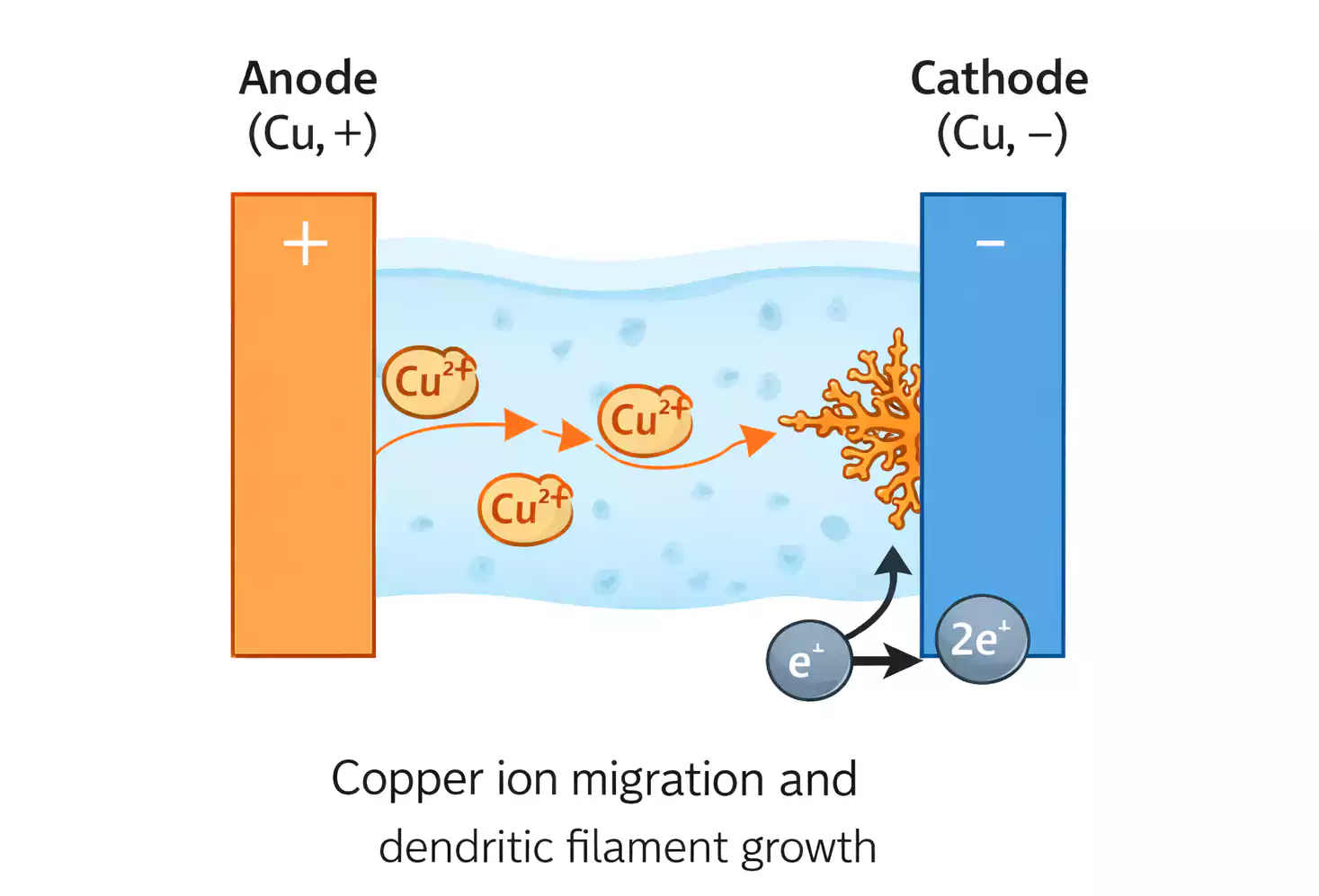
Электрохимическая последовательность роста CAF
- Влага проникает внутрь платы.
- Разность потенциалов вызывает растворение меди на аноде.
- Ионы меди мигрируют вдоль границы стекловолокно/смола.
- Они достигают катода и осаждаются, формируя металлическую нить.
- Токи утечки растут, затем возникает «жёсткое» короткое замыкание.
CAF активно развивается в условиях высокой влажности, постоянного DC-bias и длительной эксплуатации — типичный профиль для автомобильной электроники, телекоммуникаций, промышленного оборудования, авиационно-космических и медицинских систем.
Когда проектной команде стоит всерьёз учитывать CAF?
CAF наиболее критичен для проектов, где присутствуют:
- высокая влажность или конденсация
- длительный срок службы изделия (5–15 лет и более)
- постоянная разность DC-напряжений между цепями (nets)
- плотные поля переходных отверстий и многослойные stackup
- тонкие диэлектрики или HDI-конструкция
- строгие требования по надёжности (авто, авиация/космос, телеком, промышленность)
Если ваш дизайн будет подвергаться воздействию влаги, напряжения и времени, CAF нужно рассматривать как ограничение проектирования, а не как второстепенную тему.
Правила разводки PCB для предотвращения роста CAF
Практическое руководство для инженеров
Большая часть мер по снижению риска CAF реализуется не на этапе выбора материалов, производства или тестирования — а на этапе проектирования и разводки. Грамотный layout существенно уменьшает склонность к CAF ещё до изготовления платы.
Ниже — шесть наиболее эффективных правил разводки.
1) Увеличивайте расстояния между проводниками с разными потенциалами
Разность напряжений — один из главных ускорителей CAF. Увеличение зазора удлиняет путь миграции и снижает напряжённость электрического поля между проводниками.
Где особенно важно увеличивать расстояния:
- via-to-via, особенно на внутренних слоях
- trace-to-via
- цепи противоположной полярности в местах разрезов/разделения полигонов (plane splits) или вырезов (cutouts)
- цепи высокого напряжения в зонах плотной трассировки
Для внутренних слоёв нужен дополнительный запас, потому что влага часто концентрируется возле стеклоткани — именно там легче формируются пути CAF.
2) Удаляйте не подключённые площадки и внутренние «островки» меди
«Сиротские» (orphan) площадки и неиспользуемые медные фигуры на внутренних слоях создают:
- зоны с недостатком смолы
- «ловушки» для влаги
- концентрацию механических напряжений
Всё это повышает вероятность CAF.
Если площадка нужна только как опора для сверления, следуйте рекомендациям производителя и оставляйте минимально необходимое медное кольцо, вместо крупного «островка» меди.
3) Смещайте переходные отверстия примерно на 45°, чтобы избегать прямых медь-к-меди путей
Выстраивание via с противоположными потенциалами в одну линию создаёт прямой геометрический путь для ионной миграции.
Простые решения:
- повернуть пары via примерно на 45°
- либо смещать каждое второе via на 1–2 шага (pitch)
Разрыв прямого пути заметно снижает вероятность CAF, потому что ионам меди приходится проходить более длинный и извилистый маршрут через структуру стекловолокна.

4) Планируйте расстояния между via и избегайте длинных параллельных рядов via с противоположными потенциалами
CAF «любит» длинные, параллельные и близко расположенные вертикальные структуры, такие как стенки via-barrel. Если эти via находятся на разных потенциалах, риск существенно возрастает.
Лучшие практики:
- избегайте длинных параллельных рядов via
- увеличивайте drill-to-copper сверх минимальных требований производства
- для плат повышенной надёжности добавляйте 0,1–0,2 мм дополнительного зазора как правило дизайна
- смещайте колонны via, чтобы разрывать непрерывные пути CAF
Относитесь к drill-to-copper как к требованию надёжности, а не только производственной технологичности.
5) По возможности избегайте плотных «via farms»
Большие кластеры via — особенно под BGA — могут создавать:
- зоны микротрещин
- локальное обеднение смолой
- капиллярные каналы для проникновения влаги
- области повышенного электрического поля
Если высокая плотность неизбежна:
- выполняйте fan-out поэтапно, а не плотным «залпом»
- вводите локальные медные «пустоты» (keepouts) между цепями с разными потенциалами
- не группируйте без необходимости вместе via аналоговых, цифровых и силовых возвратов
Небольшие структурные изменения способны значительно снизить риск CAF.
6) Используйте teardrops на переходах pad-to-trace и via-to-trace
Teardrops усиливают зону медь-к-сверлению и уменьшают механический стресс при сверлении и ламинации. Это снижает вероятность:
- тонких волосовидных трещин
- микропустот
- зон с недостатком смолы
Эти микродефекты являются «ловушками» для влаги и ускоряют CAF.
Teardrops — простое и недорогое улучшение надёжности, особенно при трассировке с контролируемым импедансом и плотных breakout-участках.
Почему профилактика CAF зависит также от материалов и производства
CAF — не только «ошибка разводки». Это системная проблема, зависящая от:
- качества ламината (химия смолы, стеклоткань, адгезия)
- чистоты процесса (ионное загрязнение, контроль влаги)
- качества сверления (smear на стенке отверстия, трещины, отступание смолы)
- дисциплины ламинации и отверждения
- равномерности медного покрытия/металлизации
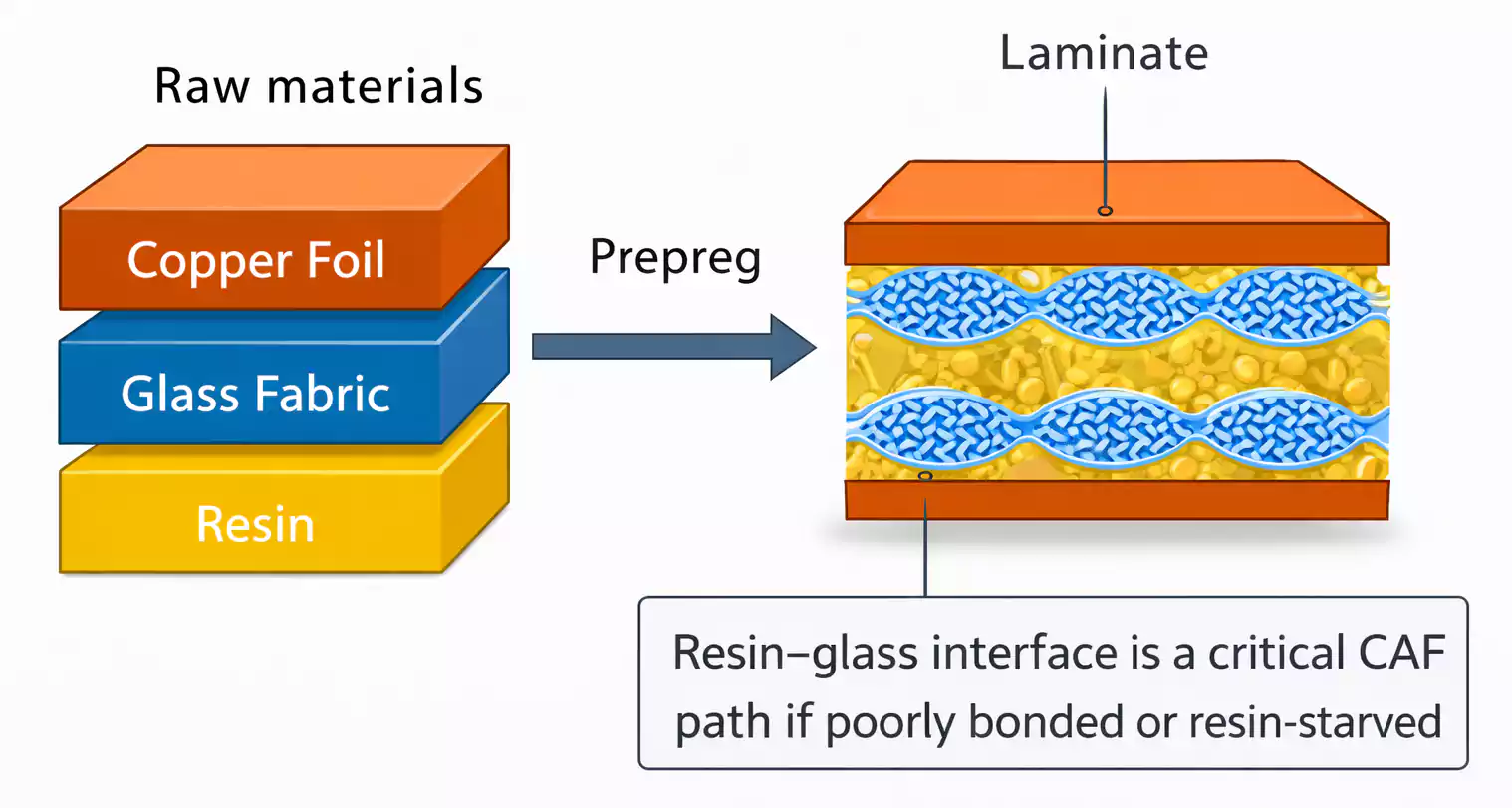
Для конструкций повышенной надёжности ранняя DFM-проработка с производителем помогает обеспечить:
- правильные классы ламината (CAF-устойчивые формулы)
- корректный выбор prepreg/смолы
- контролируемые процессы desmear и сверления
- достаточные циклы сушки (bake) для удаления влаги перед ламинацией
- стабильный stackup и согласованный выбор диэлектриков
Хороший дизайн существенно снижает риск CAF; качественное производство устраняет оставшиеся уязвимости.
FAQ по CAF: самые частые вопросы инженеров
Что такое CAF и почему это опасно?
CAF — проводящий медный «филамент», растущий внутри PCB и соединяющий две цепи, которые должны быть изолированы. Он может вызывать периодические утечки, нестабильность логики или катастрофические короткие замыкания — часто спустя месяцы или годы эксплуатации.
Почему CAF возникает на одних платах, а на других — нет?
CAF формируется, когда совпадают высокая плотность дизайна, предельные зазоры, слабые места материалов, влажность и напряжение. Даже платы из одной партии могут вести себя по-разному из-за микроскопических различий в смоле или процессе сверления.
Какие действия в разводке сильнее всего снижают риск CAF?
Самые эффективные меры: увеличение зазоров, отказ от выравнивания via в одну линию, удаление внутренних медных островков, «разбиение» плотных via-кластеров и использование teardrops.
Какие отрасли должны особенно серьёзно относиться к CAF?
Телеком, автомобильная электроника, авиация/космос, промышленная автоматика и медицинские системы — там, где длительная надёжность под воздействием влаги или напряжения обязательна.
Кто помогает обеспечить CAF-устойчивый stackup и процессы?
Надёжный партнёр по изготовлению PCB может помочь с выбором материалов, параметрами сверления, системой смол и контролем влаги — всем, что критично для снижения риска CAF.
Заключение
CAF — скрытый, но крайне важный фактор надёжности современных многослойных печатных плат. Он обусловлен электрохимической миграцией, становится возможным из-за влаги и ускоряется напряжением и слабостями материалов. К счастью, инженеры могут существенно снизить риск CAF на раннем этапе за счёт грамотных решений в layout — увеличение зазоров, смещение via, очистка внутренней меди и структурное усиление — в сочетании с правильным выбором материалов и дисциплинированными процессами производства.
Если вы проектируете устройство, которое должно годами выдерживать влажность, электрические нагрузки и критичный режим работы, важно учитывать CAF с самого первого дня разработки.