חיבור חוט זהב (Gold Wire Bonding) הוא שיטת אינטרקונקשן ותיקה, בשלה ואמינה מאוד, המשמשת באריזת רכיבי מוליכים למחצה ובחיבור Dies על גבי לוחות PCB. אבל כשביצועי ה-bonding נהיים לא עקביים, שורש הבעיה הוא לעיתים קרובות לא המכונה — אלא משטח ה-PCB.
אם הפרויקט שלך כולל Wire Bonding Gold Wire, שני גורמים ישפיעו ישירות על תפוקת החיבורים (Bonding Yield) ועל האמינות לטווח ארוך:
- עובי שכבת הזהב על פדי הבונדינג (מינימום 2 µin / 2U)
- מבנה גימור המשטח (ENEPIG מול ENIG)
המדריך הזה מסביר למה 2U הוא סטנדרט מעשי, איך חשיפת ניקל יכולה לגרום לתקלות “נסתרות”, ולמה ENEPIG הוא לרוב בחירה בטוחה יותר.
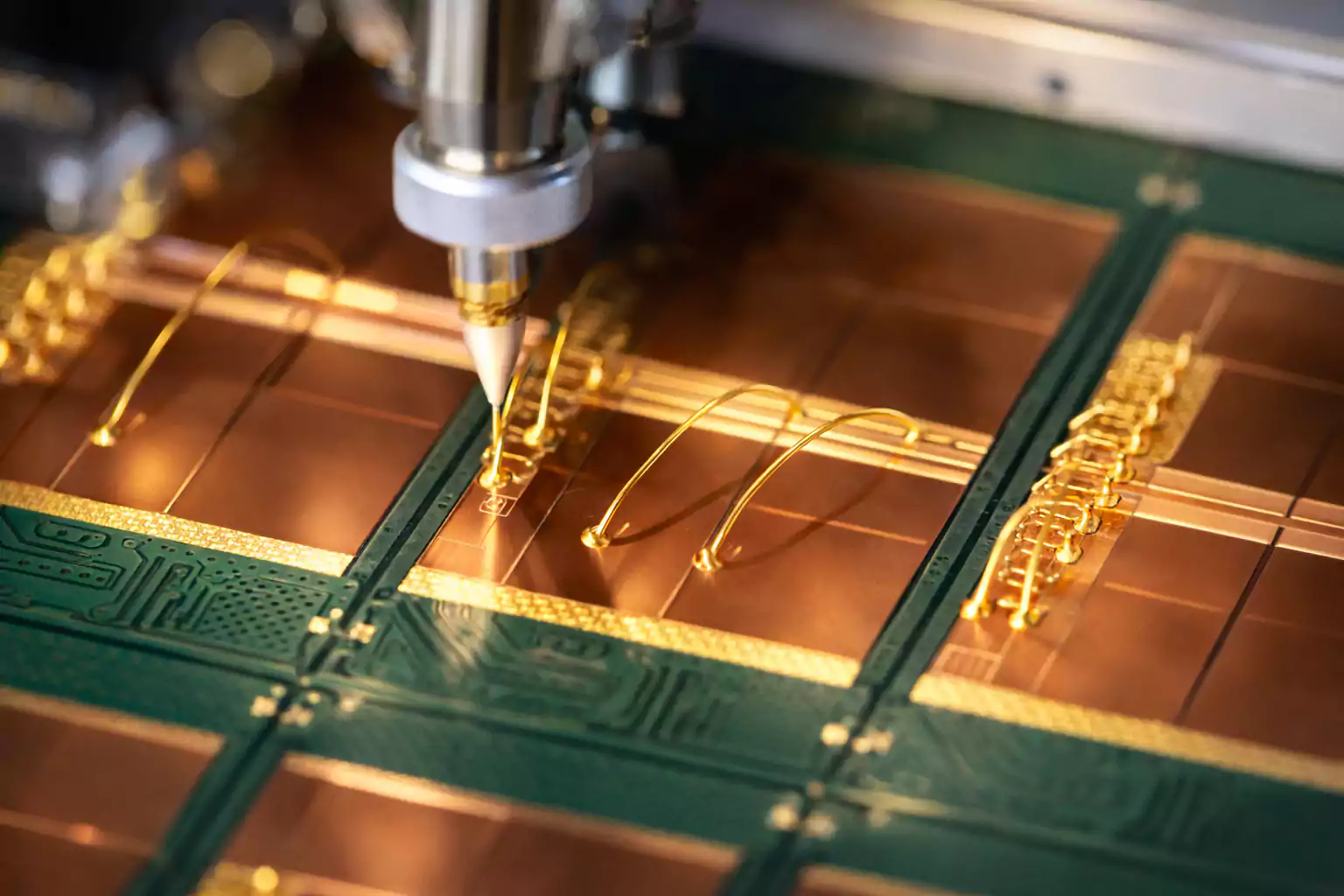
מהו Wire Bonding עם חוט זהב?
ביישומי PCB, Wire Bonding עם חוט זהב נפוץ במיוחד ב:
- מכלולי COB (Chip-on-Board)
- מודולי חיישנים
- מודולי LED
- רכיבי RF ומערכות Mixed-Signal
- מעגלים היברידיים מותאמים אישית
בניגוד להלחמה שמבוססת על מתכת מותכת, Wire Bonding Gold Wire הוא תהליך Solid-State: הוא משתמש בחום, לחץ ואנרגיה אולטרסונית מבוקרת כדי ליצור קשר מטלורגי בין חוט זהב לבין Pad מצופה על גבי ה-PCB.
מכיוון שהחיבור נשען על מגע מתכת-למתכת ועל דיפוזיה אטומית, מצב המשטח ומבנה הציפוי חשובים הרבה יותר ממה שרבים מניחים.
Ball Bonding מול Wedge Bonding
ברוב יישומי ה-PCB עם חוט זהב משתמשים ב-Ball Bonding (נקרא גם Ball-Stitch Bonding):
- נוצרת “כדורית” זהב קטנה בקצה החוט.
- הכדורית נלחצת אל Pad מחומם.
- מופעלת אנרגיה אולטרסונית.
- נוצר החיבור הראשון.
- החוט יוצר לולאה (Loop) אל ה-Pad השני.
- נוצר Stitch Bond, והחוט נחתך/מסתיים.
התהליך כולל דפורמציה מקומית ותנועת “שפשוף” מיקרוסקופית. בדיוק בגלל הפעולה המכאנית הזו עובי הזהב ושלמות המשטח הם קריטיים.
Wedge Bonding משמש בחלק מהיישומים, לעיתים קרובות עם חוט אלומיניום, אבל בסביבות die-attach על PCB — Ball Bonding עם זהב הוא הנפוץ ביותר.

למה 2U עובי זהב הוא המינימום המעשי
1) מה אומר “2U”?
2U פירושו 2 microinches (2 µin) עובי זהב.
זה שווה בערך ל-0.05 מיקרון (µm).
עובי ציפוי זהב בייצור PCB מוגדר לרוב ב-microinches. כשמדברים על 2U gold thickness for wire bonding, הכוונה היא לשכבת ה-Immersion Gold על גבי גימור ENIG או ENEPIG.
2) Wire Bonding אינו מגע “עדין”
ב-Thermosonic Bonding:
- ראש הבונדינג מפעיל כוח.
- האנרגיה האולטרסונית יוצרת micro-scrubbing (שפשוף עדין).
- נוצרת דפורמציה פלסטית מקומית.
זה מכוון: התהליך שובר שכבות שטח ומאפשר דיפוזיה במצב מוצק בין מתכות.
אבל אם שכבת הזהב דקה מדי, היא עלולה להיפגע או להישחק חלקית בזמן הבונדינג.
כשזה קורה, שכבת הניקל שמתחת מתחילה להשתתף בממשק — וכאן מתחילות בעיות האמינות.
3) חשיפת ניקל: סיכון אמינות “נסתר”
Nickel exposure קורה כאשר שכבת הזהב דקה מדי או נקבובית, כך שאנרגיית הבונדינג חודרת דרכה.
כאשר הניקל הופך לחלק מממשק הבונדינג:
- תוצאות Pull Strength נהיות לא עקביות.
- ערכי Shear מפוזרים יותר.
- התפוקה (Bonding Yield) יורדת.
- האמינות לטווח ארוך נפגעת במחזורי טמפרטורה או בלחות.
ניקל לא מתנהג כמו זהב בממשק הבונדינג. הוא משנה את חלון התהליך (Process Window) ומעלה את הרגישות לשינויים קטנים בפרמטרים.
תיקון חשוב: בטקסט המקורי הופיעה שורה “> 2 µm”. בהקשר הזה הכוונה היא > 2 µin (מיקרואינץ’), לא 2 מיקרון.
לכן 2U (2 µin) נחשב מרווח בטיחות מעשי, כי הוא מספק:
- עמידות לשחיקה במהלך אולטרסוניק
- ממשק יציב יותר של זהב-לזהב
- פחות סיכון לוריאביליות בחיבור
4) מתי צריך יותר מ-2U?
ברוב המקרים 2U מספיק, אבל יש יישומים שמצדיקים יעד גבוה יותר:
- Fine Pitch אולטרה-צפוף
- הגדרות אולטרסוניק חזקות יותר
- תרחישי Rework או Rebond
- מוצרים תעשייתיים/רכב בעלי אמינות גבוהה
- מוצרים ארוכי-חיים תחת עומס תרמי
במצבים כאלה, הגדרה של מינימום + יעד (Minimum + Target) לעובי הזהב יכולה לייצב עוד יותר את התפוקה.
גימור משטח ל-Wire Bonding: ENEPIG מול ENIG
עובי הזהב לבדו לא מספיק. המבנה שמתחת לשכבת הזהב משפיע משמעותית על ביצועי החיבור.
שני הגימורים הנפוצים ביותר ל-wire bond pads הם:
- ENIG (Electroless Nickel Immersion Gold)
- ENEPIG (Electroless Nickel Electroless Palladium Immersion Gold)
1) ENIG וסיכון ה-Black Pad
מבנה ENIG:
נחושת → ניקל כימי → זהב Immersion
ב-ENIG, ה-immersion gold שוקע ישירות על ניקל דרך תגובת החלפה (displacement). בתנאים כימיים מסוימים, התהליך יכול לתקוף את גבולות הגרעינים של שכבת הניקל.
התוצאה יכולה להיות שכבה שבירה ועשירה בזרחן — המכונה לרוב Black Pad.
בהלחמה, Black Pad עלול לגרום להלחמות שבירות. ב-Wire Bonding הוא יכול לגרום ל:
- חוסר יציבות בחוזק החיבור
- ממשק לא עקבי
- וריאביליות גבוהה יותר בתפוקת הבונדינג
תהליכי ENIG מודרניים נשלטים היטב, אבל מבנית — הזהב עדיין יושב ישירות על הניקל.
2) למה ENEPIG טוב יותר ל-Gold Wire Bonding?
מבנה ENEPIG:
נחושת → ניקל כימי → פלדיום כימי → זהב Immersion
ההבדל המרכזי הוא שכבת הפלדיום (Palladium layer).
פלדיום משמש כ:
- מחסום דיפוזיה (Diffusion Barrier)
- מתכת אצילה עמידה לקורוזיה
- שכבת הגנה מעל הניקל
ב-ENEPIG הזהב שוקע על הפלדיום ולא ישירות על הניקל. זה מפחית את הסיכוי לקורוזיה בניקל ומקטין משמעותית את סיכון ה-Black Pad.
ליישומים בעלי אמינות גבוהה, ENEPIG מספק ממשק יציב יותר ותפוקת בונדינג עקבית יותר בהשוואה ל-ENIG.

3) מתי ENIG עדיין יכול להספיק?
ENIG עשוי להספיק כאשר:
- דרישות האמינות בינוניות
- ה-bond pitch אינו קיצוני
- היצרן שומר על בקרת תהליך מצוינת
- מגבלות עלות משמעותיות
אבל כאשר העדיפות היא:
- תפוקת בונדינג מקסימלית
- אמינות גבוהה במיוחד
- COB בצפיפות גבוהה (fine-pitch)
- אלקטרוניקה לרכב או מערכות קריטיות
בדרך כלל ENEPIG הוא הבחירה הבטוחה והשמרנית יותר.
גורמים נוספים שמשפיעים על Bonding Yield
עובי הזהב וגימור המשטח הם הבסיס — אך לא המשתנים היחידים.
1) ניקיון המשטח
Gold wire bonding רגיש מאוד לזיהומים:
- שאריות אורגניות
- טביעות אצבע
- חשיפה לגופרית
- יצירת אוקסידים
- זיהום ממסכת הלחמה (Solder mask)
אפילו זיהום קטן יכול לצמצם את חלון התהליך ולגרום לתפוקה לא עקבית.
נדרש Handling נקי ואריזה נכונה.
2) גאומטריית Pad ומרווח מסכת הלחמה
הגדרת Pad לא טובה יכולה לפגוע ב-bonding:
- חדירה של מסכת הלחמה (encroachment)
- קצוות לא אחידים
- מרווח לא מספיק
- אי-אחידות שטח
ב-Fine Pitch חשוב במיוחד שה-pad יהיה שטוח ואחיד כדי להעביר אנרגיה אולטרסונית בצורה עקבית.
3) אחסון וטיפול
מצב המשטח יכול להידרדר לאורך זמן אם האחסון אינו מתאים.
Best practices כוללות:
- אריזה מבוקרת
- סביבת אחסון אנטי-גופרית
- צמצום חשיפה לאוויר לפני bonding
- הימנעות ממגע מיותר עם ה-pads
יציבות המשטח משפיעה ישירות על אמינות החיבור.
FAQ: Wire Bonding Gold Wire
מהו עובי זהב 2U?
2U שווה ל-2 µin (מיקרואינץ’), בערך 0.05 מיקרון. זהו מינימום מעשי לבונדינג יציב עם חוט זהב.
למה ENEPIG מועדף ל-gold wire bonding?
ENEPIG כולל שכבת פלדיום שמגינה על הניקל ומפחיתה את סיכון ה-Black Pad. כך מתקבל ממשק יציב יותר ותפוקה עקבית יותר.
מהו Black Pad ב-ENIG?
Black Pad הוא פגם קורוזיבי בשכבת הניקל הכימית שעלול להחליש את הממשק ולגרום לשונות בביצועים מכאניים.
איך מונעים חשיפת ניקל בזמן bonding?
להגדיר עובי זהב מספיק (≥ 2U מינימום).
להשתמש ב-ENEPIG ליישומי אמינות גבוהה.
לוודא בקרת תהליך טובה אצל יצרן ה-PCB.
להימנע מאנרגיית אולטרסוניק מוגזמת מחוץ לחלון התהליך.
סיכום
Wire Bonding Gold Wire הוא אמין, אך רגיש לשינויים בעובי הזהב ובמבנה גימור המשטח — והם משפיעים על התפוקה ועל אמינות לאורך זמן.
ברוב יישומי ה-PCB wire bonding:
- עובי זהב ≥ 2U צריך להיחשב דרישת בסיס.
- ENEPIG הוא בחירה בטוחה יותר מ-ENIG כאשר אמינות היא קריטית.
- מניעת חשיפת ניקל וצמצום סיכון Black Pad הם המפתח לביצועים יציבים.
ב-FastTurnPCB אנו עובדים עם לקוחות על מכלולי COB, מודולים בצפיפות גבוהה ואלקטרוניקה אמינה במיוחד, כדי לוודא שגימור המשטח ועובי הזהב מוגדרים נכון כבר מההתחלה. החלטות נכונות מוקדם חוסכות הפסדי תפוקה יקרים בשלבי הייצור המאוחרים.