Le wire bonding au fil d’or (liaison par fil d’or) est une méthode d’interconnexion mature et très fiable, largement utilisée en packaging des semi-conducteurs et pour l’assemblage de dies sur PCB. Pourtant, lorsque les performances deviennent instables, la cause racine n’est souvent pas la machine de bonding — mais l’état de surface du PCB.
Si votre projet implique du Wire Bonding Gold Wire, deux facteurs vont influencer directement votre rendement de bonding et la fiabilité à long terme :
- Épaisseur d’or sur les pads de bonding (minimum 2 µin / 2U)
- Structure de finition de surface (ENEPIG vs ENIG)
Ce guide explique pourquoi 2U d’or est une référence, comment l’exposition du nickel peut entraîner des défauts difficiles à détecter, et pourquoi l’ENEPIG est généralement un choix plus sûr.
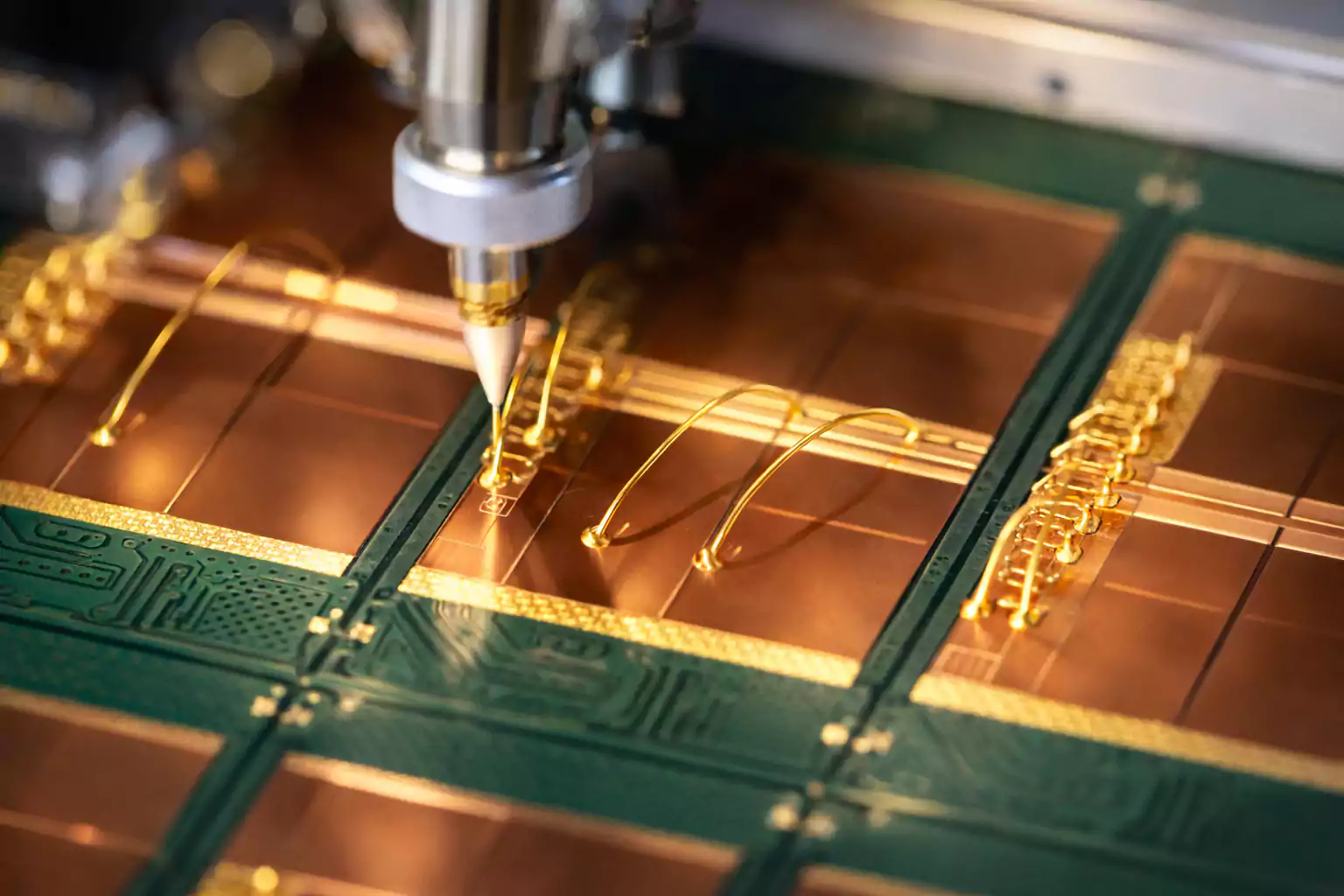
Qu’est-ce que le wire bonding au fil d’or ?
Dans les applications PCB, le wire bonding au fil d’or est couramment utilisé pour :
- Assemblages COB (Chip-on-Board)
- Modules capteurs
- Modules LED
- Dispositifs RF et circuits mixtes (mixed-signal)
- Circuits hybrides sur mesure
Contrairement à la soudure, qui utilise un métal fondu, le Wire Bonding Gold Wire est un procédé à l’état solide. Il met en œuvre une chaleur, une pression et une énergie ultrasonore contrôlées pour former une liaison métallurgique entre un fil d’or et un pad de PCB métallisé.
Comme la liaison repose sur un contact métal-métal et une diffusion atomique, l’état de surface et la structure du dépôt sont plus importants que beaucoup d’ingénieurs ne l’imaginent.
Ball bonding vs wedge bonding
La plupart des applications PCB au fil d’or utilisent le ball bonding (aussi appelé ball-stitch bonding) :
- Une petite bille d’or est formée à l’extrémité du fil.
- La bille est pressée sur un pad chauffé.
- Une énergie ultrasonore est appliquée.
- La première liaison se forme.
- Le fil est bouclé vers le second pad.
- Une liaison de type stitch est réalisée, puis le fil est coupé.
Ce procédé implique une déformation localisée et un micro-frottement. C’est précisément cette action mécanique qui rend l’épaisseur d’or et l’intégrité de surface critiques.
Le wedge bonding est utilisé dans certaines applications, souvent avec du fil aluminium, mais le ball bonding à l’or domine dans la plupart des environnements d’assemblage de die sur PCB.

Pourquoi 2U d’or est le minimum pratique
1) Que signifie “2U” ?
2U signifie 2 micro-pouces (2 µin) d’épaisseur d’or.
Cela correspond à environ 0,05 µm.
En fabrication PCB, l’épaisseur du dépôt d’or est généralement spécifiée en micro-pouces. Quand on parle de 2U gold thickness for wire bonding, on vise la couche d’or par immersion (immersion gold) des finitions ENIG ou ENEPIG.
2) Le wire bonding n’est pas un simple contact “doux”
Lors d’un bonding thermosonique :
- La tête de bonding applique une force.
- L’énergie ultrasonore introduit un micro-scrubbing (micro-frottement).
- Une déformation plastique localisée se produit.
C’est volontaire : le procédé casse les films de surface et permet la diffusion solide entre métaux.
Cependant, si la couche d’or est trop fine, elle peut être perturbée ou partiellement usée pendant le bonding.
Quand cela arrive, la couche de nickel sous-jacente peut intervenir dans l’interface — et c’est là que les problèmes de fiabilité commencent.
3) Exposition du nickel : un risque de fiabilité “caché”
L’exposition du nickel survient lorsque la couche d’or est trop fine ou trop poreuse, laissant l’énergie de bonding pénétrer jusqu’au nickel.
Lorsque le nickel devient partie intégrante de l’interface :
- Les résultats de pull test deviennent incohérents.
- Les valeurs de shear présentent une dispersion plus large.
- Le rendement de bonding chute.
- La fiabilité à long terme se dégrade sous cycles thermiques ou humidité.
Le nickel ne se comporte pas comme l’or à l’interface. Il modifie la fenêtre de procédé (process window) et augmente la sensibilité aux petites variations de paramètres.
Correction importante : dans le texte source, une ligne mentionne “> 2 µm”. Ici, le bon ordre de grandeur est > 2 µin (micro-pouces), pas 2 microns.
C’est pourquoi 2U (2 µin) est considéré comme une marge de sécurité pratique. Elle apporte :
- Une tolérance à l’usure due aux ultrasons
- Une interface or-or plus stable
- Une réduction du risque de variabilité de bonding
4) Quand faut-il plus que 2U ?
2U est souvent suffisant, mais certaines situations justifient des cibles plus élevées :
- Bonding à pas ultra-fin (ultra-fine pitch)
- Réglages d’énergie ultrasonore plus élevés
- Scénarios de retouche / rebond (rework, rebond)
- Produits automobiles ou industriels à haute fiabilité
- Produits longue durée soumis à stress thermique
Dans ces cas, spécifier à la fois un minimum et une cible (minimum + target) peut améliorer la stabilité du rendement.
Finition de surface pour wire bonding : ENEPIG vs ENIG
L’épaisseur d’or seule ne suffit pas. La structure sous la couche d’or joue un rôle majeur.
Les deux finitions les plus courantes pour pads de wire bond sont :
- ENIG (Electroless Nickel Immersion Gold)
- ENEPIG (Electroless Nickel Electroless Palladium Immersion Gold)
1) ENIG et risque de “black pad”
Structure ENIG :
Cuivre → Nickel chimique → Or par immersion
En ENIG, l’or par immersion se dépose directement sur le nickel via une réaction de déplacement. Dans certaines conditions chimiques, cette réaction peut attaquer les joints de grains du nickel.
Le résultat peut être une couche fragile riche en phosphore — souvent appelée black pad.
En soudure, le black pad peut provoquer des joints fragiles. En wire bonding, il peut contribuer à :
- Une instabilité de la résistance de liaison
- Une interface incohérente
- Une variabilité accrue du rendement de bonding
Les procédés ENIG modernes sont bien contrôlés, mais structurellement l’or reste déposé directement sur le nickel.
2) Pourquoi l’ENEPIG est meilleur pour le wire bonding au fil d’or
Structure ENEPIG :
Cuivre → Nickel chimique → Palladium chimique → Or par immersion
La différence clé est la couche de palladium.
Le palladium agit comme :
- Barrière de diffusion
- Métal noble résistant à la corrosion
- Couche protectrice au-dessus du nickel
En ENEPIG, l’or se dépose sur le palladium, et non directement sur le nickel. Cela réduit la probabilité de corrosion du nickel et diminue fortement le risque de black pad.
Pour les applications à haute fiabilité, l’ENEPIG offre une interface plus stable et un rendement de bonding plus constant que l’ENIG.

3) Quand l’ENIG reste acceptable ?
L’ENIG peut convenir si :
- Les exigences de fiabilité sont modérées
- Le pas de bonding n’est pas extrêmement fin
- Le fabricant maîtrise très bien son procédé
- Les contraintes de coût sont fortes
Mais lorsque la priorité est :
- Rendement maximal
- Haute fiabilité de wire bonding
- COB à pas fin
- Électronique automobile ou critique (mission-critical)
Alors l’ENEPIG est généralement un choix plus sûr et plus conservateur.
Autres facteurs qui influencent le rendement de bonding
L’épaisseur d’or et la finition de surface sont essentielles — mais ce ne sont pas les seuls paramètres.
1) Propreté de surface
Le bonding au fil d’or est extrêmement sensible à la contamination :
- Résidus organiques
- Empreintes digitales
- Exposition au soufre
- Formation d’oxydes
- Contamination par masque de soudure
Même une faible contamination peut réduire la fenêtre de procédé et entraîner des rendements irréguliers.
Une manipulation propre et un packaging adapté sont indispensables.
2) Géométrie des pads et dégagement du masque
Une mauvaise définition du pad peut nuire au bonding :
- Empiètement du masque de soudure
- Bords irréguliers
- Dégagement insuffisant
- Irrégularités de surface
Le bonding à pas fin requiert des pads plats et homogènes pour transférer l’énergie ultrasonore de façon uniforme.
3) Stockage et manipulation
L’état de surface peut se dégrader avec le temps si le stockage n’est pas correct.
Bonnes pratiques :
- Emballage contrôlé
- Stockage anti-soufre
- Minimiser l’exposition à l’air avant bonding
- Éviter tout contact inutile avec les pads
La stabilité de surface impacte directement la fiabilité.
FAQ : Wire Bonding Gold Wire
Quelle est l’épaisseur d’or 2U ?
2U correspond à 2 micro-pouces (2 µin), soit environ 0,05 µm. C’est un minimum pratique pour obtenir un bonding stable.
Pourquoi l’ENEPIG est-il préféré pour le fil d’or ?
L’ENEPIG intègre une couche de palladium qui protège le nickel et réduit le risque de black pad. Résultat : interfaces plus stables et rendements plus constants.
Qu’est-ce que le black pad en ENIG ?
C’est un défaut de corrosion de la couche de nickel chimique pouvant fragiliser l’interface et augmenter la variabilité des performances mécaniques.
Comment éviter l’exposition du nickel pendant le bonding ?
Spécifier une épaisseur d’or suffisante (≥ 2U).
Utiliser l’ENEPIG pour les applications à haute fiabilité.
S’assurer du bon contrôle de procédé chez le fabricant PCB.
Éviter une énergie ultrasonore excessive hors fenêtre de procédé.
Conclusion
Le Wire Bonding Gold Wire est fiable, mais sensible aux variations d’épaisseur d’or et de finition de surface, qui affectent le rendement et la fiabilité à long terme.
Pour la plupart des applications de wire bonding sur PCB :
- Une épaisseur d’or ≥ 2U doit être considérée comme une exigence de base.
- L’ENEPIG est un choix plus sûr que l’ENIG pour les applications à forte exigence de fiabilité.
- Éviter l’exposition du nickel et réduire le risque de black pad sont clés pour des performances stables.
Chez FastTurnPCB, nous accompagnons nos clients sur des assemblages COB, des modules à pas fin et des produits à haute fiabilité, afin de garantir que la finition de surface et l’épaisseur d’or sont correctement définies dès le départ. Bien cadrer ces points en amont permet d’éviter des pertes de rendement coûteuses plus tard en production.

