Da moderne Elektronik immer höhere Geschwindigkeiten, stärkere Integration und kleinere Bauformen verlangt, ist das BGA PCB board zur zentralen Grundlage fortschrittlicher Hardware-Designs geworden. Von Prozessoren und FPGAs bis hin zu DDR-Speicher und High-Speed-SoCs ermöglichen Ball Grid Array (BGA)-Gehäuse eine enorme I/O-Dichte auf kleinstem Raum.
Doch mit dieser Dichte steigt auch die Komplexität.
Ein zuverlässiges BGA PCB board zu entwerfen bedeutet nicht nur, Pins zu verbinden. Es erfordert einen strukturierten, ingenieurgetriebenen Ansatz, der folgende Aspekte in Einklang bringt:
- Intelligente BGA-Platzierung
- Eine klar definierte Fanout-Strategie
- Saubere Stack-up-Planung (Lagenaufbau)
- Hohe Signal Integrity (SI) und Power Integrity (PI)
- Strikte Design for Manufacturability (DFM)-Vorgaben
Dieser Leitfaden fasst die wichtigsten Regeln zusammen, die erfahrene PCB-Designer anwenden, damit BGA-Layouts beim ersten Durchlauf funktionieren.
Mit Fanout anfangen — nicht mit Routing
Einer der häufigsten Layout-Fehler? Direkt mit dem Routing zu beginnen, bevor die Breakout-Strategie feststeht.
1. Was ist BGA-Fanout?
Fanout ist die kurze „Escape“-Verbindung von einem BGA-Pad (Ball) zu einem Via oder Routing-Kanal. Es ist der Übergang von extrem dichter Pad-Geometrie zu einem Routing-Bereich, der praktisch nutzbar ist.
In High-Density-Designs bestimmt Fanout:
- Ob Signale physisch aus dem Package herausgeführt werden können
- Wie viele Lagen benötigt werden
- Ob HDI-Strukturen erforderlich sind
- Ob später Routing-Engpässe entstehen
Wenn Fanout nicht zuerst geplant wird, endet man häufig bei:
- Unerwartet zusätzlichem Lagenbedarf
- Umstieg auf Blind/Buried Vias mitten im Design
- Problemen mit der Signal Integrity
- Höheren Fertigungskosten
2. Kernregel
Definieren Sie Ihre BGA-Fanout-Strategie, bevor Sie mit globalem Routing beginnen.
Betrachten Sie das BGA als Schwerpunkt der Leiterplatte. Speicher, Taktquellen, PMICs und Steckverbinder sollten darum herum angeordnet werden — nicht umgekehrt.
BGA-Platzierung: Signale kurz und zuverlässig halten
Platzierungsentscheidungen bestimmen, ob Ihr Layout sauber und effizient ist — oder verstopft und anfällig.
1. Zentrale Positionierungsstrategie
Bei den meisten prozessorbasierten Designs sollte das Haupt-BGA nahe der Platinenmitte platziert werden. Das hilft:
- Routing gleichmäßig in alle Richtungen zu verteilen
- Thermische Symmetrie beim Reflow zu verbessern
- Mechanische Spannungsspitzen zu reduzieren
Ein zentral platziertes BGA führt typischerweise zu einem ausgewogeneren Layout.
2. Kritische Bauteile nah platzieren
Platzieren Sie high-speed- und timingkritische Komponenten so nahe wie möglich am BGA:
- DDR-Speicher – Leiterbahnlängen und Skew minimieren
- Taktquellen – Kurz, direkt und mit möglichst wenigen Vias routen
- PMICs – Kürzere Power-Loops verbessern die Power Integrity
- Flash-Bausteine – Latenz und Impedanzsprünge reduzieren
Lange Signalwege erhöhen:
- Skew-Mismatch
- Einfügedämpfung (Insertion Loss)
- Übersprechen (Crosstalk)
- Reflexionsrisiko
Kürzer ist fast immer besser.
3. Multi-BGA-Systeme
In Designs mit mehreren großen BGAs (CPU + FPGA, SoC + GPU) wird der Abstand kritisch.
Sie müssen Routing-Kanäle zwischen den Bauteilen reservieren. Ohne diese Planung wird der Bereich zwischen den BGAs zu einer Routing-„Todeszone“.
Planen Sie das im Floorplanning — nicht erst nach Beginn des Routings.
4. Wie nah darf ein BGA an den Platinenrand?
Eine häufige Frage.
Empfohlener Abstand: mindestens 7–10 mm vom BGA-Rand zum PCB-Rand.
Warum?
- Platinenränder erleben beim Reflow stärkere Temperaturgradienten
- Mechanische Belastungen sind am Rand größer
- Ungleichmäßige Erwärmung erhöht das Risiko für kalte Lötstellen oder Lötfehler
Ausreichender Abstand verbessert Ausbeute und Langzeitzuverlässigkeit.
Stack-up-Planung für BGA-Breakout
Der Lagenaufbau entscheidet oft darüber, ob ein BGA-Design überhaupt realisierbar ist.
1. Pitch treibt die Technologie
Mit kleinerem BGA-Pitch:
- Schrumpft der Abstand Pad-zu-Pad
- Werden Routing-Kanäle enger
- Wird kontrollierte Impedanz schwieriger
- Passen Standard-Through-hole-Vias ggf. nicht mehr
Kleiner Pitch erfordert oft:
- Dünnere Dielektrika
- Höhere Lagenzahlen
- HDI-Stack-ups (1+N+1, 2+N+2)
- Microvias oder Via-in-Pad
2. Abschätzung der benötigten Lagenzahl
Eine praxisnahe Faustregel:
- Rund 60 % der BGA-Balls sind Signale
- Der Rest ist typischerweise Power und GND
Power- und GND-Balls können oft direkt auf Planes geführt werden.
Signal-Balls benötigen Routing-Kanäle — und jede Lage kann nur eine begrenzte Anzahl an Signalen „escape“ routen.
Wenn innere Reihen nicht über die Außenlagen herausgeführt werden können, sind zusätzliche Signallagen erforderlich.
3. Durchgehende Referenzflächen sind Pflicht
Jede High-Speed-Signallage sollte eine solide, benachbarte Referenzfläche haben.
Vermeiden Sie:
- Routing über gesplittete Ground-Planes
- Das Überqueren von Plane-Voids
- Rückstrompfade, die Umwege machen müssen
Durchgehende Referenzflächen sorgen für:
- Stabile Impedanz
- Saubere Rückstrompfade
- Weniger EMI
- Bessere Signal Integrity
BGA-Fanout-Strategie: Die richtige Breakout-Methode wählen
Fanout ist nicht „one size fits all“. Die Wahl hängt von Pitch, Kosten und Fertigungsfähigkeit ab.
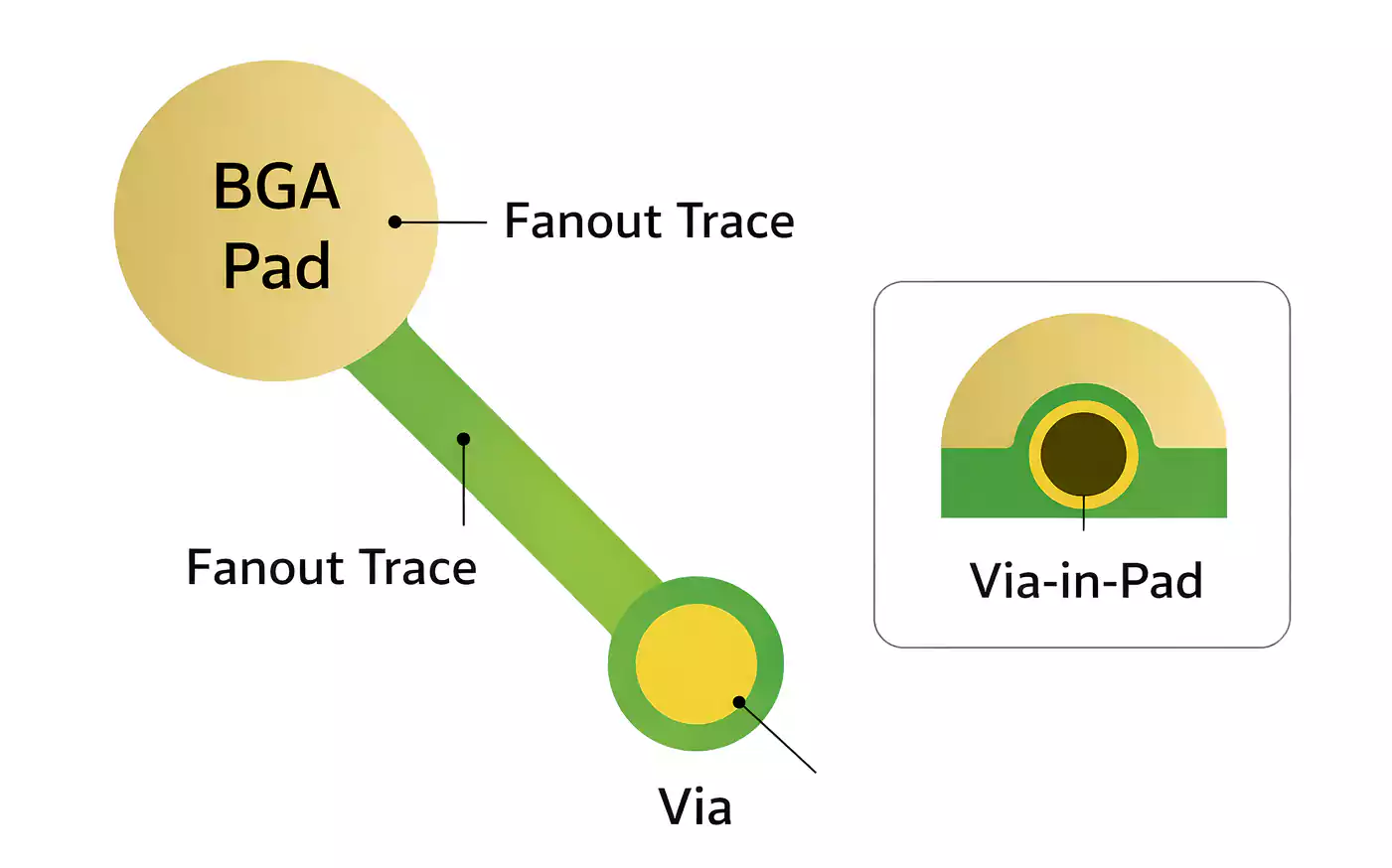
1. Äußere Balls zuerst (Outside-In-Breakout)
Routen Sie immer zuerst die äußere ein bis zwei Reihen.
Äußere Reihen:
- Bieten mehr Routing-Flexibilität
- Erhalten Kanäle für die inneren Reihen
- Reduzieren Engpässe
Wird der äußere Routing-Platz zu früh „verbraucht“, können innere Balls unmöglich zu escapen sein.
Fanout sollte Ring für Ring von außen nach innen erfolgen.

2. Dog-Bone-Fanout
Die klassische Dog-Bone-Struktur besteht aus:
- Einer kurzen Leiterbahn (Neck)
- Einem Via (Head)
Am besten geeignet für:
- Moderaten Pitch (z. B. 0,8 mm oder größer)
- Standard-Through-hole-Prozesse
- Kostenkritische Designs
Dog-Bone-Fanout ist zuverlässig, weit verbreitet und leicht zu fertigen.
3. Via-in-Pad (VIP)
Wenn der Pitch auf 0,5 mm oder kleiner sinkt, ist ein Via zwischen Pads oft nicht mehr möglich.
Via-in-Pad platziert das Via direkt im Pad und routet Signale auf Innenlagen.
Vorteile:
- Maximale Breakout-Dichte
- Saubere Routing-Kanäle
- Effiziente Flächennutzung
Nachteile/Trade-offs:
- Filled & plated Vias erforderlich
- Höhere Fertigungskosten
- Höhere Prozessanforderungen
Wichtig: Verwenden Sie im gesamten BGA-Bereich einen konsistenten Breakout-Stil. Stil-Mix erhöht das Fertigungsrisiko.
Pad-Design und Soldermask-Aspekte
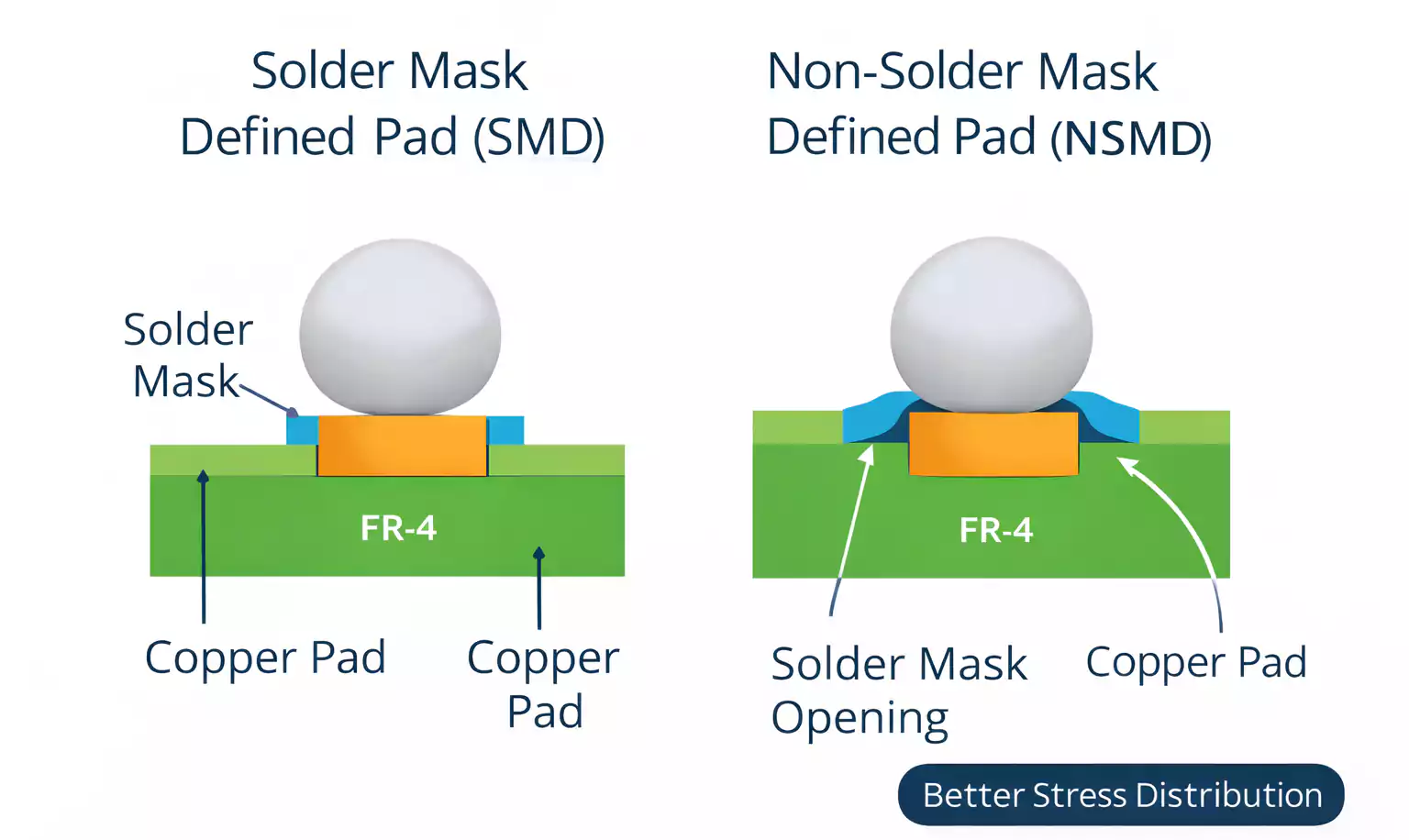
1. NSMD vs. SMD-Pads
In den meisten BGA PCB board-Designs sind NSMD-Pads (Non-Solder Mask Defined) bevorzugt.
Warum NSMD?
- Voller Kupferrand ist freigelegt
- Bessere Spannungsverteilung in der Lötstelle
- Höhere Zuverlässigkeit
- Oft mehr Routing-Flexibilität
SMD-Pads können sinnvoll sein, wenn eine engere Soldermask-Kontrolle oder höhere Pad-Haftung benötigt wird. NSMD ist jedoch meist der Industriestandard.
2. Soldermask-Bridge: Das versteckte Risiko
Die Soldermask-Bridge ist der schmale Maskensteg zwischen benachbarten Pads.
Sie ist die einzige physische Barriere gegen Lötbrücken.
Mit kleinerem Pitch:
- Werden Maskenstege schmaler
- Werden Fertigungstoleranzen kritischer
- Steigt das Bridging-Risiko
Bestätigen Sie daher die minimale Soldermask-Fähigkeit Ihres Herstellers, bevor Sie die Pad-Geometrie finalisieren.
Via-Regeln und DFM-Constraints
1. Mindestabstand Via-zu-Pad
Empfohlenes Minimum:
≥ 3–4 mil (0,075–0,1 mm) zwischen Via-Annular-Ring und Pad-Kante.
Wenn Vias zu nah platziert sind:
- Werden Soldermask-Stege fragil
- Steigen Fertigungsfehler
- Sinkt die Lötzuverlässigkeit
Allein diese Regel verhindert viele BGA-Assembly-Probleme.
2. Via-in-Pad-Füllanforderungen
Bei Via-in-Pad gilt:
- Vias müssen korrekt gefüllt werden (Epoxy oder Kupfer)
- Oberfläche muss planarisiert sein
- Beschichtung muss gleichmäßig sein
Schlechte Füllung kann zu Solder-Wicking oder Voids führen.
3. DFM ist nicht verhandelbar
Prüfen Sie frühzeitig:
- Minimale Leiterbahnbreite/Abstände
- Minimaler Bohrdurchmesser
- Annular-Ring-Anforderungen
- Masken-Alignment-Toleranzen
Elektrisches Design und Fertigungsfähigkeit müssen zusammenpassen.
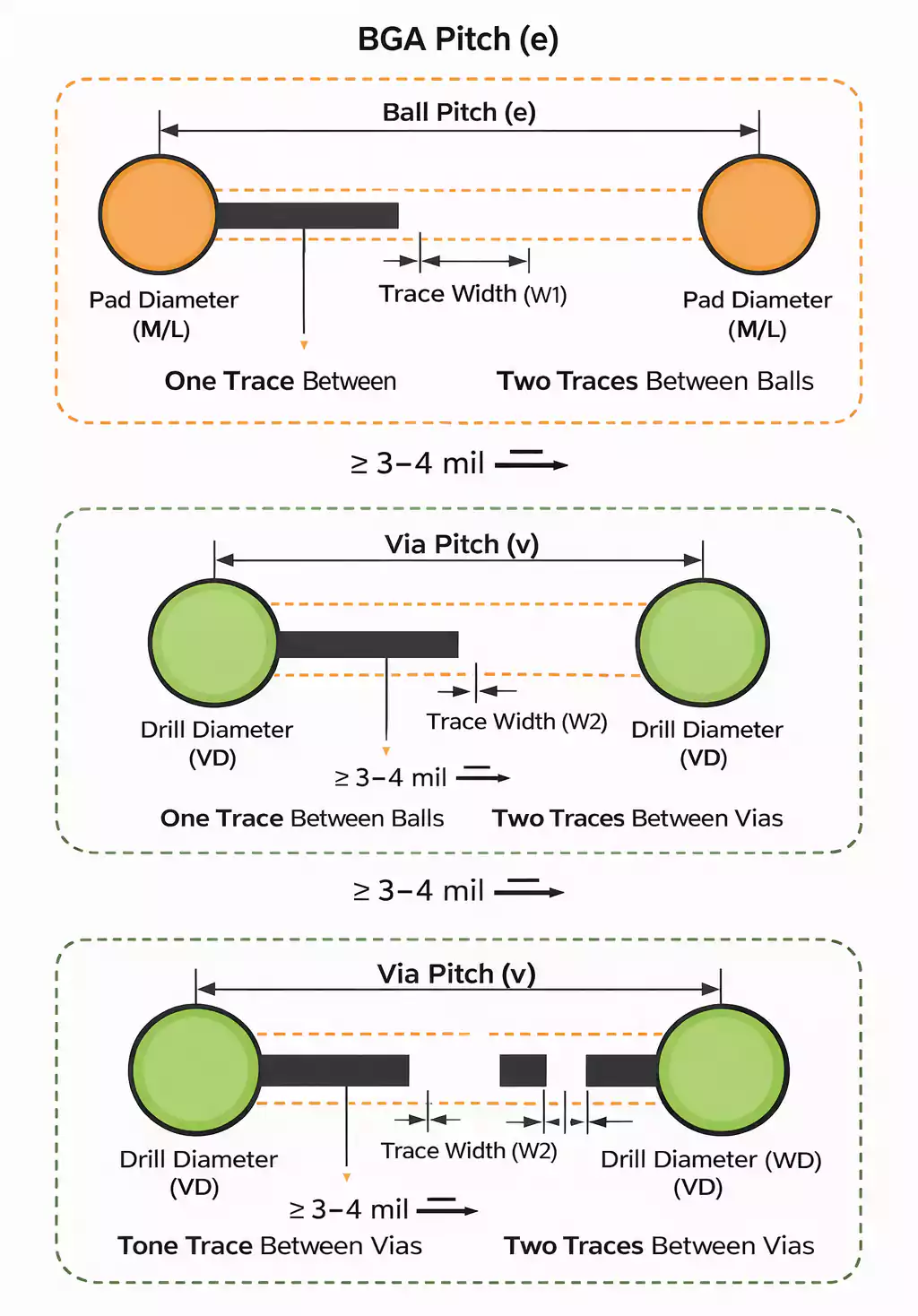
BGA-Routing-Best-Practices
1. Orthogonales Routing zwischen Lagen
Benachbarte Signallagen sollten um 90° versetzt geroutet werden:
- Lage 1: Horizontal
- Lage 2: Vertikal
- Lage 3: Horizontal
Das reduziert Broadside-Crosstalk und verbessert die Routing-Übersicht.
2. Layer-Transitions bei High-Speed begrenzen
Jedes Via verursacht:
- Impedanzdiskontinuität
- Stub-Effekte
- Änderungen des Rückstrompfads
Für Signale über 1 GHz sollte man auf eine Lagenumschaltung oder weniger abzielen, wenn möglich.
Idealer Pfad:
- Aus dem BGA-Pad heraus
- Einmal umschalten
- Direkt zum Ziel routen
Weniger Transitions = bessere Signal Integrity.
3. Via-Stubs managen
Through-hole-Vias erzeugen ungenutzte Stub-Längen, die als Resonatoren wirken.
Mögliche Maßnahmen:
- Microvias verwenden
- Unbenutzte Via-Abschnitte backdrillen
- Via-Länge minimieren
High-Speed-Performance hängt stark von der Kontrolle dieser Parasiten ab.
Flip-Chip-BGA: Zusätzliche Zuverlässigkeitsaspekte
Flip-Chip-BGA-Packages sind mechanisch und thermisch sensibler.
Wesentliche Unterschiede:
- Die wird umgedreht und direkt kontaktiert
- Thermischer Pfad ist anders
- Spannungsverteilung verändert sich
Design-Implikationen:
- Symmetrisches, ausgewogenes Layout
- Sorgfältige Platzierung thermischer Vias
- Kontrolliertes Heat-Spreading
- Konsistente Land-Pattern-Geometrie
Die Zuverlässigkeit hängt stärker von mechanischem Gleichgewicht und Thermomanagement ab.
Finale Checkliste für BGA PCB Boards
Vor dem Release sollten Sie prüfen:
- Fanout ist vor dem Routing definiert
- Äußere Balls zuerst geroutet
- Durchgehende Referenzflächen unter High-Speed-Netzen
- NSMD-Pads korrekt definiert
- Via-zu-Pad-Abstand ≥ 3–4 mil
- BGA-Abstand zum Platinenrand ≥ 7–10 mm
- High-Speed-Netze mit minimalen Layer-Transitions
- Orthogonales Routing zwischen benachbarten Signallagen
Wenn diese Bedingungen erfüllt sind, ist die Wahrscheinlichkeit deutlich höher, dass Ihr BGA PCB board Fertigung und Assembly ohne Überraschungen besteht.
Fazit
BGA-PCB-Design ist ein disziplinierter Engineering-Prozess. Es geht nicht nur um Dichte — sondern um Balance:
- Platzierung, die kritische Pfade minimiert
- Fanout, der Routing-Flexibilität erhält
- Stack-up, der saubere Rückstrompfade ermöglicht
- Pad- und Via-Regeln, die zur Fertigungsfähigkeit passen
- Routing, das die Signal Integrity schützt
Wenn Sie diese Elemente systematisch umsetzen, erreichen Sie hohe Performance, gute Herstellbarkeit und langfristige Zuverlässigkeit.
Bei FastTurnPCB arbeiten wir eng mit Engineering-Teams zusammen, um BGA-Layouts sowohl für Performance als auch für Produktion zu optimieren. Ob Standard-Multilayer oder fortschrittliche HDI-BGA-Technologie: Die Abstimmung der Layout-Strategie mit den Fertigungsmöglichkeiten ist der Schlüssel zum Erfolg im ersten Durchlauf.