مع توجه الإلكترونيات الحديثة نحو سرعات أعلى، ودمج أكبر، وأحجام أصغر، أصبحت لوحة BGA PCB board حجر الأساس في تصميم العتاد المتقدم. من المعالجات وشرائح FPGA إلى ذاكرة DDR وSoC عالية السرعة، تتيح حزم Ball Grid Array (BGA) كثافة هائلة من نقاط الإدخال/الإخراج ضمن مساحة صغيرة.
لكن هذه الكثافة تعني أيضًا تعقيدًا أعلى.
إن تصميم لوحة BGA PCB board موثوقة لا يقتصر على “توصيل الأرجل” فقط. بل يتطلب منهجًا هندسيًا منظمًا يوازن بين:
- تموضع ذكي لحزمة BGA (BGA placement)
- استراتيجية Fanout واضحة ومحددة
- تخطيط صحيح للـ Stack-up (ترتيب طبقات اللوحة)
- سلامة الإشارة (SI) وسلامة القدرة (PI)
- الالتزام الصارم بقواعد التصميم للتصنيع (DFM)
هذا الدليل يلخص القواعد الأساسية التي يعتمدها مصممو PCB المحترفون لضمان نجاح تخطيط BGA من أول مرة.
ابدأ بالـ Fanout — وليس بالتوجيه (Routing)
من أكثر أخطاء التخطيط شيوعًا: البدء بالتوجيه قبل تحديد استراتيجية الخروج (Breakout).
1) ما هو BGA Fanout؟
الـ Fanout هو مسار “الهروب” القصير الذي يصل بين نقطة اللحام في BGA (الكرة/الـ Pad) وبين Via أو قناة توجيه. وهو يمثل الانتقال من منطقة Pads شديدة الكثافة إلى مساحة توجيه قابلة للاستخدام.
في التصميمات عالية الكثافة، يحدد الـ Fanout:
- هل يمكن للإشارات أن “تخرج” فعليًا من الحزمة؟
- كم عدد الطبقات المطلوبة؟
- هل نحتاج إلى بنية HDI؟
- هل سيحدث ازدحام توجيه لاحقًا؟
إذا لم تخطط للـ Fanout منذ البداية، فغالبًا ستنتهي إلى:
- إضافة طبقات بشكل غير متوقع
- التحول إلى Blind/Buried Vias في منتصف التصميم
- مواجهة مشاكل في سلامة الإشارة
- زيادة تكلفة التصنيع
2) القاعدة الأساسية
حدد استراتيجية Fanout قبل بدء أي توجيه عام في اللوحة.
اعتبر BGA “مركز الثقل” في الـ PCB. يجب أن تُرتَّب الذاكرة، والـ Clocks، ودوائر إدارة الطاقة PMIC، والموصلات حولها — وليس العكس.
تموضع BGA: اجعل الإشارات أقصر وأكثر موثوقية
قرارات التموضع تحدد ما إذا كان تخطيطك نظيفًا وفعالًا — أو مزدحمًا وهشًّا.
1) استراتيجية التموضع في المنتصف
في معظم التصميمات المعتمدة على المعالجات، يُفضَّل وضع الـ BGA الرئيسي بالقرب من وسط اللوحة. هذا يساعد على:
- توزيع التوجيه بالتساوي في جميع الاتجاهات
- تحسين التماثل الحراري أثناء إعادة اللحام (Reflow)
- تقليل تركّز الإجهاد الميكانيكي
عادةً ما ينتج عن التموضع المركزي تخطيط أكثر توازنًا.
2) ضع العناصر الحساسة قريبًا
ضع المكونات عالية السرعة والحساسة للتوقيت أقرب ما يمكن إلى الـ BGA:
- ذاكرة DDR — تقليل طول المسارات وفروق التأخير (Skew)
- مصادر الساعة (Clock) — توجيه قصير ومباشر وبأقل عدد Vias
- PMIC — حلقات قدرة أقصر تعني PI أفضل
- ذاكرة الفلاش — تقليل التأخير وعدم استمرارية المعاوقة
المسارات الطويلة تزيد من:
- اختلافات الـ Skew
- خسارة الإدراج (Insertion Loss)
- التداخل (Crosstalk)
- مخاطر الانعكاسات (Reflection)
الأقصر غالبًا أفضل.
3) أنظمة متعددة BGA
في التصميمات التي تحتوي على أكثر من BGA كبير (مثل CPU + FPGA أو SoC + GPU)، تصبح المسافات حاسمة.
يجب حجز “قنوات توجيه” بين الحزم. بدون ذلك تتحول المنطقة بينهما إلى منطقة توجيه “ميتة”.
خطط لهذا أثناء الـ Floorplanning — وليس بعد بدء التوجيه.
4) كم يمكن أن تقترب BGA من حافة اللوحة؟
سؤال شائع.
الخلوص الموصى به: 7–10 مم على الأقل من حافة BGA إلى حافة PCB.
لماذا؟
- حواف اللوحة تتعرض لفروق حرارة أكبر أثناء Reflow
- الإجهاد الميكانيكي يتضاعف قرب الحواف
- التسخين غير المتساوي يزيد احتمال اللحام البارد أو عيوب اللحام
الخلوص المناسب يحسن مردود التجميع والموثوقية طويلة الأمد.
تخطيط طبقات اللوحة (Stack-Up) لخروج BGA
الـ Stack-up في كثير من الأحيان يحدد ما إذا كان تصميم BGA ممكنًا من الأساس.
1) الـ Pitch يحدد التقنية
كلما صغُر Pitch حزمة BGA:
- تقل المسافة بين الـ Pads
- تضيق قنوات التوجيه
- يصبح التحكم في المعاوقة (Controlled Impedance) أصعب
- قد لا تعود الـ Through-hole Vias مناسبة
وغالبًا ما يتطلب Pitch صغير:
- عوازل أرق (Thinner dielectrics)
- عدد طبقات أكبر
- HDI stack-ups مثل (1+N+1, 2+N+2)
- Microvias أو Via-in-Pad
2) تقدير عدد الطبقات المطلوبة
قاعدة عملية مفيدة:
- حوالي 60% من كرات BGA تكون إشارات
- والباقي غالبًا قدرة وأرضي
كرات القدرة/الأرضي يمكن غالبًا إسقاطها مباشرة إلى طبقات الـ Planes.
أما الإشارات فتحتاج قنوات خروج، وكل طبقة يمكنها إخراج عدد محدود منها.
إذا لم تتمكن الصفوف الداخلية من الخروج على الطبقات السطحية، ستحتاج إلى طبقات إشارات إضافية.
3) ضرورة وجود مستويات مرجعية متصلة (Continuous Reference Planes)
كل طبقة إشارات عالية السرعة يجب أن يكون بجانبها مستوى مرجعي صلب ومتصّل.
تجنب:
- التوجيه فوق أرضي مقسّم (Split ground)
- عبور فراغات/ثقوب في الـ Plane (Plane voids)
- إجبار تيار الرجوع على الالتفاف (Return path detour)
المستويات المرجعية المتصلة تضمن:
- معاوقة مستقرة
- مسارات رجوع نظيفة
- EMI أقل
- سلامة إشارة أقوى
استراتيجية Fanout: اختيار طريقة الـ Breakout المناسبة
الـ Fanout ليس قالبًا واحدًا للجميع. الاختيار يعتمد على الـ Pitch والكلفة وقدرة المصنع.
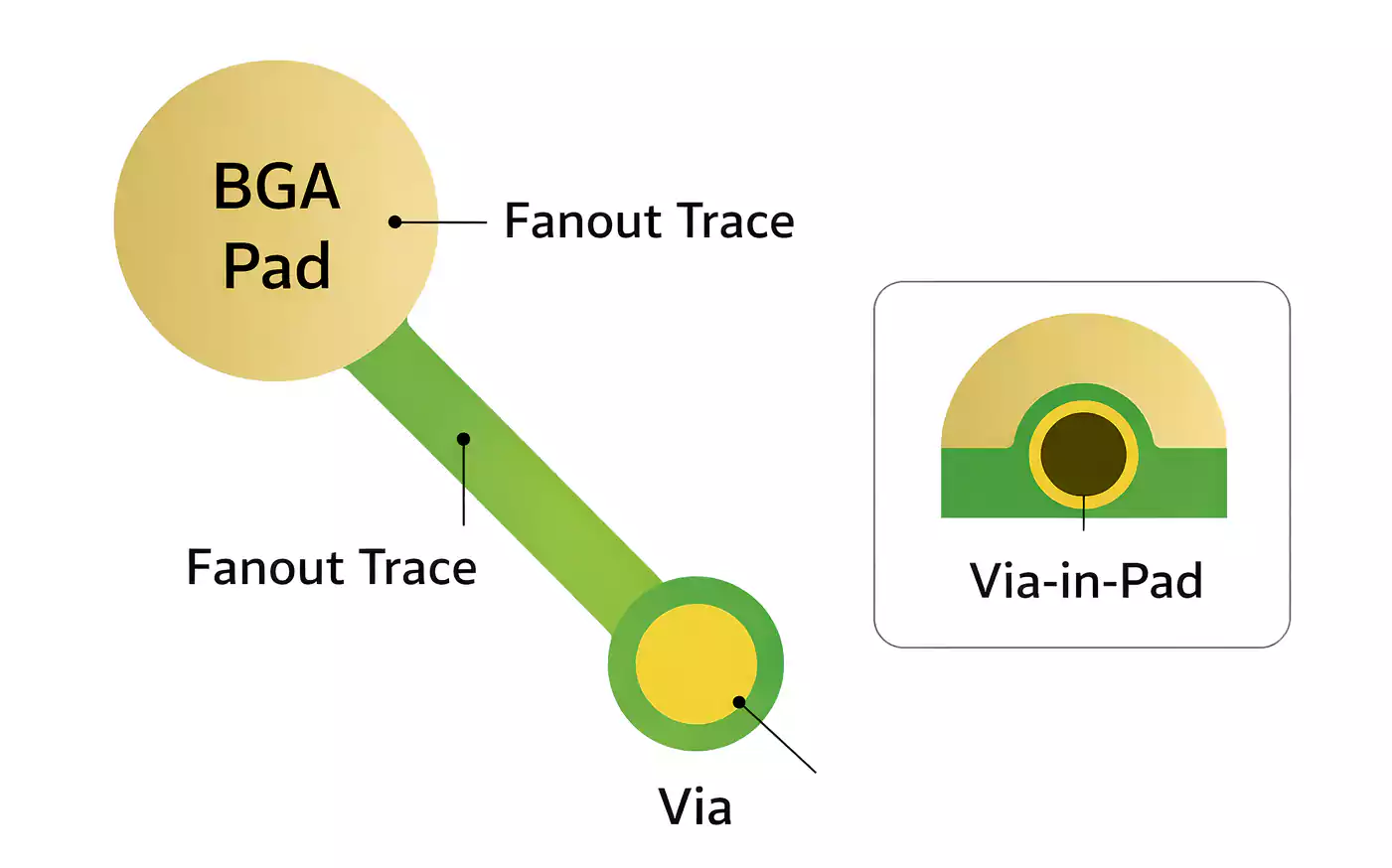
1) الصفوف الخارجية أولاً (Outside-In Breakout)
ابدأ دائمًا بالصف الخارجي أو الصفين الخارجيين.
الصفوف الخارجية:
- أكثر مرونة للتوجيه
- تحفظ قنوات للصفوف الداخلية
- تقلل الازدحام
إذا أهدرت مساحة التوجيه الخارجية مبكرًا، قد يصبح خروج الصفوف الداخلية مستحيلاً.
يجب أن يتم الـ Fanout “حلقة بحلقة” من الخارج إلى الداخل.

2) Dog-Bone Fanout
تركيب الـ Dog-bone الكلاسيكي يتكون من:
- مسار قصير (Neck)
- Via (Head)
مناسب لـ:
- Pitch متوسط (مثل 0.8 مم أو أكبر)
- عمليات Through-hole القياسية
- التصميمات الحساسة للكلفة
الـ Dog-bone شائع وموثوق وسهل التصنيع.
3) Via-in-Pad (VIP)
عندما ينخفض الـ Pitch إلى 0.5 مم أو أقل، قد يصبح وضع Via بين الـ Pads غير ممكن.
في Via-in-Pad يتم وضع الـ Via داخل الـ Pad مباشرةً، ويتم توجيه الإشارات على الطبقات الداخلية.
المزايا:
- كثافة خروج قصوى
- قنوات توجيه أنظف
- استخدام أفضل للمساحة
التحديات:
- يتطلب Vias مملوءة ومطلية (Filled & Plated)
- كلفة تصنيع أعلى
- تحكمًا أدق في العملية
مهم: استخدم نمط Breakout واحدًا متسقًا عبر منطقة BGA. خلط الأنماط يزيد مخاطر التصنيع.
تصميم الـ Pads واعتبارات الـ Solder Mask
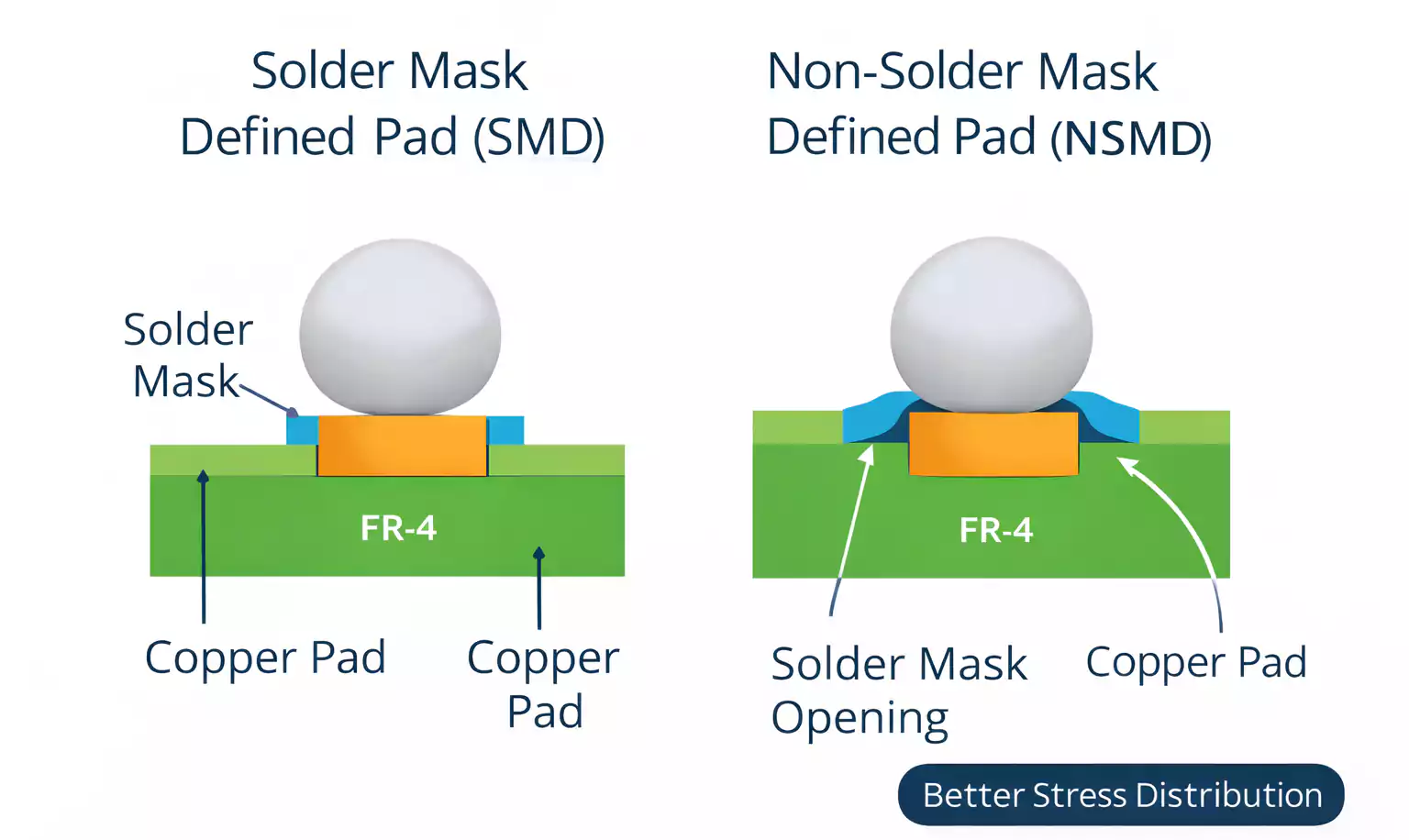
1) NSMD مقابل SMD
في معظم تصميمات BGA PCB board، تُفضَّل Pads من نوع NSMD (Non-Solder Mask Defined).
لماذا NSMD؟
- محيط النحاس مكشوف بالكامل
- توزيع أفضل للإجهاد على لحام الكرة
- موثوقية أعلى
- غالبًا مرونة أكبر للتوجيه
قد تُستخدم Pads من نوع SMD عندما تكون هناك حاجة لتحكم أدق في الـ Solder Mask أو التصاق أعلى للـ Pad، لكن NSMD غالبًا هو الخيار القياسي في الصناعة.
2) جسر الـ Solder Mask: الخطر الخفي
جسر الـ Solder Mask هو الشريط الرفيع من القناع بين Pads المتجاورة.
وهو الحاجز الفيزيائي الوحيد لمنع جسر القصدير (Solder bridging).
كلما صغر الـ Pitch:
- تضيق جسور القناع
- تصبح سماحية التصنيع أكثر حساسية
- تزيد احتمالات الجسر
تأكد دائمًا من قدرة مصنعك على الحد الأدنى للقناع قبل اعتماد أبعاد الـ Pads.
قواعد الـ Via وقيود DFM
1) أقل مسافة بين Via والـ Pad
الحد الأدنى الموصى به:
≥ 3–4 mil (0.075–0.1 مم) بين حافة حلقة الـ Via (annular ring) وحافة الـ Pad.
إذا كانت الـ Vias قريبة جدًا:
- تصبح جسور الـ Solder Mask هشة
- تزيد عيوب التصنيع
- تتدهور موثوقية اللحام
هذه القاعدة وحدها تمنع العديد من أعطال تجميع BGA.
2) متطلبات تعبئة Via-in-Pad
عند استخدام Via-in-Pad:
- يجب تعبئة الـ Vias بشكل صحيح (إيبوكسي أو نحاس)
- يجب تسوية السطح (Planarization)
- يجب أن يكون الطلاء منتظمًا
التعبئة السيئة قد تسبب سحب القصدير داخل الـ Via (Solder wicking) أو فراغات (Voids).
3) التصميم للتصنيع غير قابل للتفاوض
تحقق مبكرًا من:
- أقل عرض/تباعد مسارات
- أقل قطر حفر
- متطلبات الـ Annular ring
- سماحية محاذاة الـ Mask
يجب أن يتوافق التصميم الكهربائي مع قدرة التصنيع.
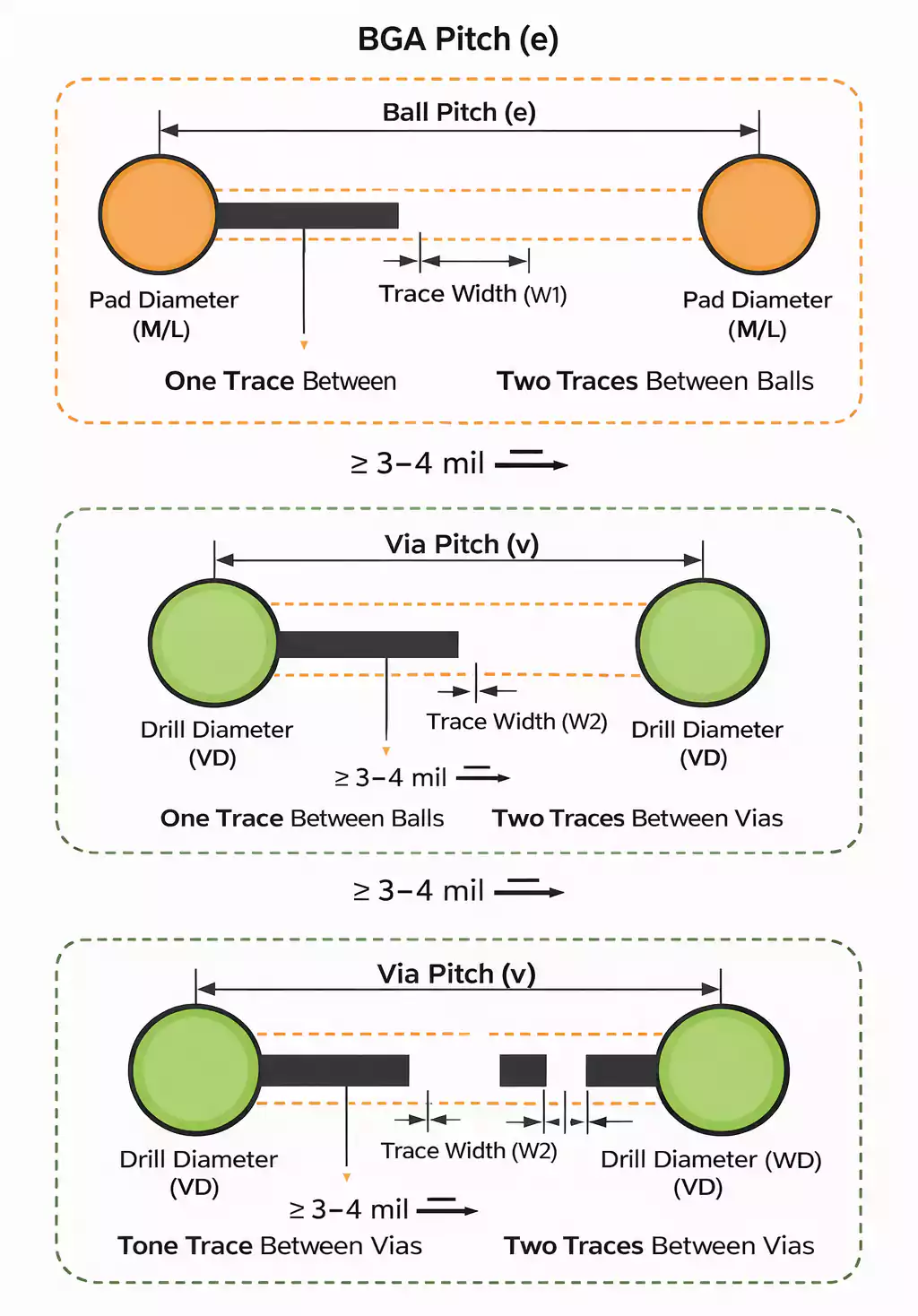
أفضل ممارسات توجيه BGA (Routing)
1) توجيه متعامد بين الطبقات (Orthogonal Routing)
اجعل طبقات الإشارة المتجاورة متعامدة 90°:
- الطبقة 1: أفقي
- الطبقة 2: عمودي
- الطبقة 3: أفقي
هذا يقلل التداخل العريض (Broadside crosstalk) ويحسن وضوح التوجيه.
2) تقليل الانتقال بين الطبقات للإشارات عالية السرعة
كل Via يسبب:
- عدم استمرارية المعاوقة
- تأثير Stub
- تغيّر مسار الرجوع
للإشارات فوق 1 GHz، حاول أن يكون عدد الانتقالات بين الطبقات مرة واحدة أو أقل قدر الإمكان.
المسار المثالي:
- الخروج من Pad
- انتقال واحد
- توجيه مباشر للوجهة
كلما قلّت الانتقالات تحسنت سلامة الإشارة.
3) إدارة Via Stubs
الـ Through-hole Vias تترك Stubs غير مستخدمة تعمل كعناصر رنين.
طرق التخفيف:
- استخدام Microvias
- Backdrill للأجزاء غير المستخدمة
- تقليل طول الـ Via
الأداء عالي السرعة يعتمد على التحكم بهذه التأثيرات الطفيلية.
Flip-Chip BGA: اعتبارات إضافية للموثوقية
حزم Flip-chip BGA أكثر حساسية ميكانيكيًا وحراريًا.
الاختلافات الرئيسية:
- يتم قلب الشريحة وتوصيلها مباشرةً
- يختلف مسار التبديد الحراري
- تتغير توزيعات الإجهاد
الانعكاسات التصميمية:
- تماثل وتوازن التخطيط
- توزيع مدروس لـ Thermal vias
- نشر حراري جيد (Heat spreading)
- هندسة Pads متسقة
تصبح الموثوقية أكثر اعتمادًا على التوازن الميكانيكي والإدارة الحرارية.
قائمة التحقق النهائية لـ BGA PCB Board
قبل إرسال التصميم للتصنيع، تأكد من:
- تم تحديد الـ Fanout قبل التوجيه
- تم توجيه الصفوف الخارجية أولاً
- وجود مستويات مرجعية متصلة تحت الشبكات عالية السرعة
- تعريف Pads من نوع NSMD بشكل صحيح
- مسافة Via-to-Pad ≥ 3–4 mil
- خلوص BGA عن الحافة ≥ 7–10 مم
- تقليل انتقالات الطبقات للشبكات عالية السرعة
- التوجيه المتعامد بين طبقات الإشارة المتجاورة
إذا تحققت هذه الشروط، ففرص نجاح لوحة BGA PCB board في التصنيع والتجميع دون مفاجآت تكون أعلى بكثير.
الخلاصة
تصميم BGA PCB board هو عملية هندسية منضبطة. ليس الهدف فقط تحقيق كثافة أعلى — بل تحقيق “توازن” بين:
- تموضع يقلل أطوال المسارات الحرجة
- Fanout يحافظ على مرونة التوجيه
- Stack-up يوفر مسارات رجوع نظيفة
- قواعد Pads وVias متوافقة مع قدرة التصنيع
- Routing يحمي سلامة الإشارة
عندما تُعالج هذه العناصر بشكل منهجي، ستحصل على أداء أعلى، وقابلية تصنيع أفضل، وموثوقية طويلة الأمد.
في FastTurnPCB، نعمل عن قرب مع فرق الهندسة لضمان أن تخطيطات BGA محسنة للأداء والإنتاج معًا. سواء كان مشروعك يحتاج لوحات متعددة الطبقات قياسية أو تقنيات HDI متقدمة لـ BGA، فإن مواءمة استراتيجية التخطيط مع قدرة التصنيع هي الطريق الأسرع لنجاح التصميم من أول مرة.